为了在物联网(IoT)环境中保持竞争力,中型工业和过程测量技术公司必须越来越多地将其传感器电路集成到ASIC(专用集成电路)上。半导体行业目前正在以较低的开发流程成本和较低的生产门槛来满足这一需求。但是,这种趋势在芯片封装中并未充分发生。结果,需要单独封装的ASIC冒着使主要位于亚洲的封装服务提供商面临数量障碍的风险。由来自工业和研究领域的七个合作伙伴组成的德国联盟现在正在提供替代解决方案。
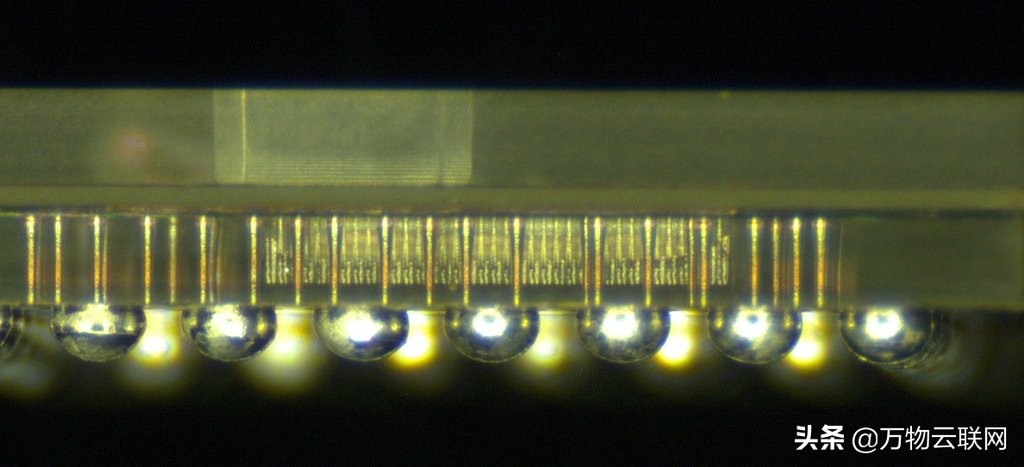
图1:玻璃封装的侧视图显示了三层结构,玻璃通孔和焊球
上述需求概况的一个很好的例子是用于工业和过程测量技术的雷达传感器的研究项目,该项目部分由德国教育和研究部(BMBF)资助。该项目的标题为“用于高频应用的高度紧凑的电子系统的玻璃中介层技术(GlaRA)”。 100 GHz以上的频率高于蜂窝技术的频率,并且严格的环境要求不允许使用标准IC封装。这些组件必须适用于专用传感器ASIC,同时必须以具有竞争力的成本以中等数量制造。
该联盟已经建立并确定了一种基于玻璃的可靠中介层技术,该技术用于宽带毫米波模块,并以系统级封装(SiP)的形式应用于传感器技术和100 GHz以上频率的通信。展示的模块化技术系统代表了传感器封装的一场革命:与现有技术相比,它增加了可以通过各种波导概念,高密度微布线和密封封装进行集成的功能。此外,由于其高水平的准确性和材料质量,它可以使应用达到300 GHz。这是使用玻璃制成的单一系统材料,除其他外,它还具有出色的波导性能和高精度的微加工。
通过使用带有电馈通(通孔)的玻璃中介层,展示了一种密封封装,其中组件被封装在两个玻璃中介层之间(图1)。这些封装是在直径达300毫米的晶圆级上制造的。晶圆级封装的特点是,由于许多组件的并行处理以及在RF技术严格公差范围内的对准精度,因此成本适中。为此,使用了适用于处理硅晶片的标准系统,这大大加快了商业实施。玻璃还可以采用大面板形式,这使得将制造工艺扩大到大批量生产变得更加容易。

图2:封装的俯视图显示了导体走线,ASIC和波导支架(底面积5.9 mm x 4.4 mm)
结果表明,由BMBF资助的研发项目取得了非凡的成功。该财团通过在Endress + Hauser AG上建立了一个非常紧凑的雷达前端(用于未来的雷达液位传感器)以160 GHz的工作频率进行了演示。该玻璃封装尺寸很小(5.9毫米x 4.4毫米x 0.8毫米),包含采用SiGe技术的雷达ASIC,用于与外部电子设备连接的所有电气连接,用于表征的测试结构以及波导连接,它们也可以用作集成了用于透镜天线的主辐射器(图2)。这种未来的液位传感器的特点是距离分辨率高,测量精度高,光束聚焦和非常紧凑的尺寸。因此,对于智能过程测量技术的系统尺寸越来越小,模块化程度更高的应用,它们非常有意义。
演示者使用了一条新颖的工艺链,从LPKF Laser&Electronics AG的革命性激光诱导深蚀刻(LIDE)开始。在玻璃中产生微结构的工艺完全避免了对玻璃基板的任何损坏,这使得易于管理和密封的玻璃封装成为可能。弗劳恩霍夫可靠性与微集成研究所(IZM)实施了一种工业化工艺,以使高纵横比的玻璃通孔金属化。在晶片键合过程中,通过接合两个玻璃晶片将组装的组件密封封装,每个玻璃晶片都有通孔和空腔。
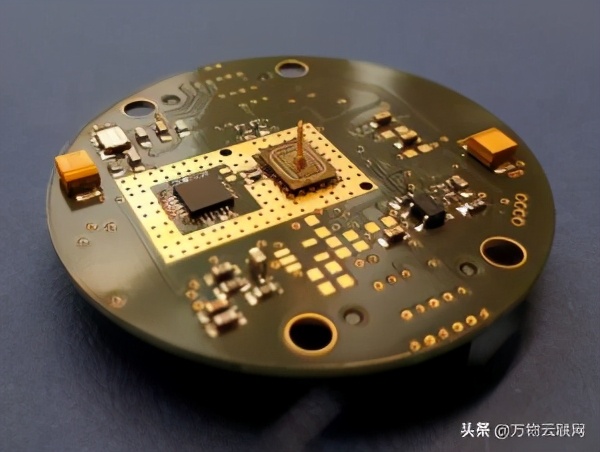
图3:一个内置的雷达传感器,中央有一个玻璃封装,并附有介电波导
玻璃基板上的导体走线的结构化和金属化是由PacTech GmbH完成的。 PacTech的SB²工艺是一种基于激光的工艺,用于依次施加焊球,在没有外部电流的情况下将焊料沉积物沉积。不同的合金用于在不同的温度下进行交错组装。 MSG Lithoglas GmbH通过生产用于容纳ASIC的空腔来支持高频封装的实现。由玻璃制成的高精度垫片也通过低温涂层生产。
乌尔姆大学微波技术研究所开发的新封装具有高频应用的概念,超过100 GHz的雷达信号既可以通过主辐射器直接照亮镜头,又可以路由到远端天线而几乎不没有通过柔性介质波导的损耗(图3)。利用从包装中发射雷达信号的各种选项,可以满足广泛的应用。 Sentronics Metrology GmbH开发了3D高速传感器,其层分辨率在亚纳米范围内,用于质量控制。除其他事项外,该传感器还具有密封,抽空玻璃封装的泄漏测试的能力。
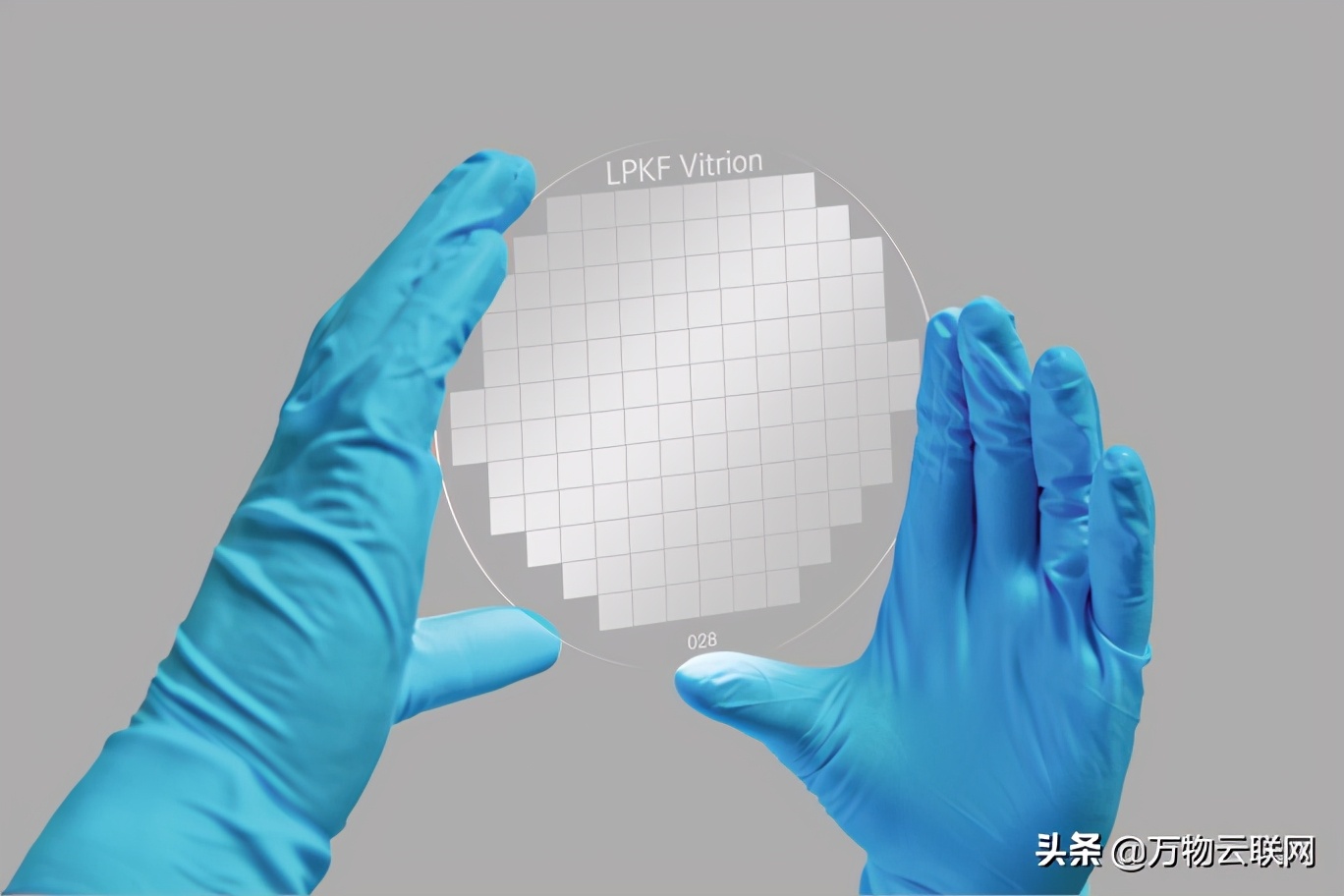
图4、玻璃封装项目
工业伙伴对该技术的未来商业可用性非常感兴趣。他们看到5G以外的其他许多应用领域的潜力,例如压力测量技术,液体分析,光子学,MEMS,医疗技术和通信技术。
作为TechSys征集建议书的一部分,“ GlaRA”项目由BMBF于2017年8月至2021年3月资助,编号为16ES0687K。