随着IC 封装技术的发展,I/O 数量增多、布线密度增大、基板层数增多,使得传统的四边引角扁平封装(Quad Flat Package,QFP)等封装形式在其发展上有所限制,20 世纪90年代中期以球栅阵列封装(Ball Grid Array,BGA)、芯片级封装(Chip Scale Package,CSP)为代表的新型 IC 封装形式问世,解决了封装引脚共面度、脚距过细和面积过大等问题。

传统引脚型芯片 BGA芯片(同样大小芯片 IO可多几倍)
现在采用BGA封装的产品有很多种,如常见的电脑显卡、南北桥、CPU,在手机、投影仪、电视等产品中也有BGA元器件。 SMT贴片BGA芯片应用已经越来越多,但是,对BGA芯片SMT中的各项焊接工艺,作为工程师的你真的了解“透”了吗?
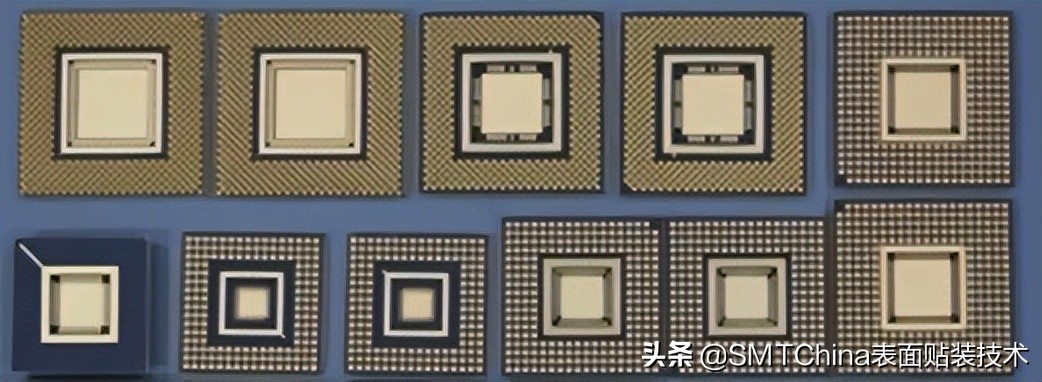
BGA:即Ball Grid Array(球栅阵列封装)

正常的BGA焊接
1、BGA锡球脱落问题
1、SMT接合工法・回流式自动机・锡膏・SMT基板概要・锡球脱落
2、SMT接合工法・不良发生原因比率・锡球脱落注目

3.锡球狭缢现象、脱落现象、界面剥离现象
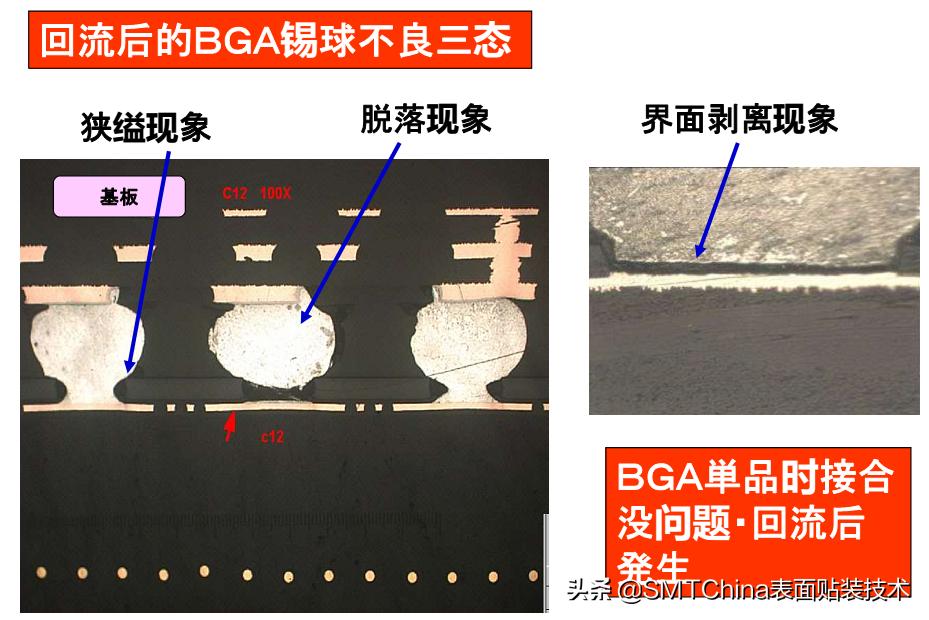
4.CSP、BGA接合部工程别不良发生要因:接合及接合后锡球形状変化(狭缢现象或锡球脱落要因)
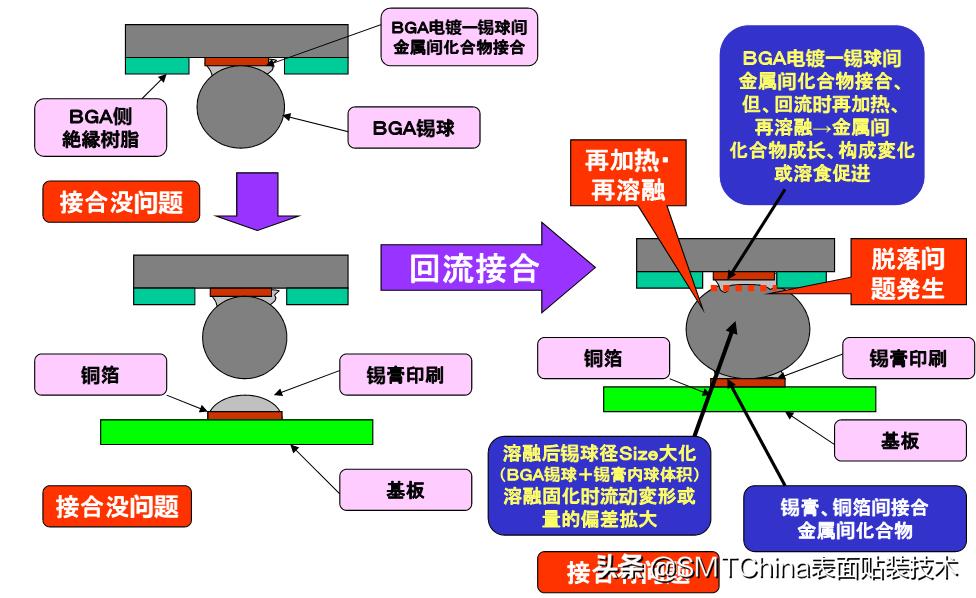
5.锡球脱落及变形现象分类及问题点整理
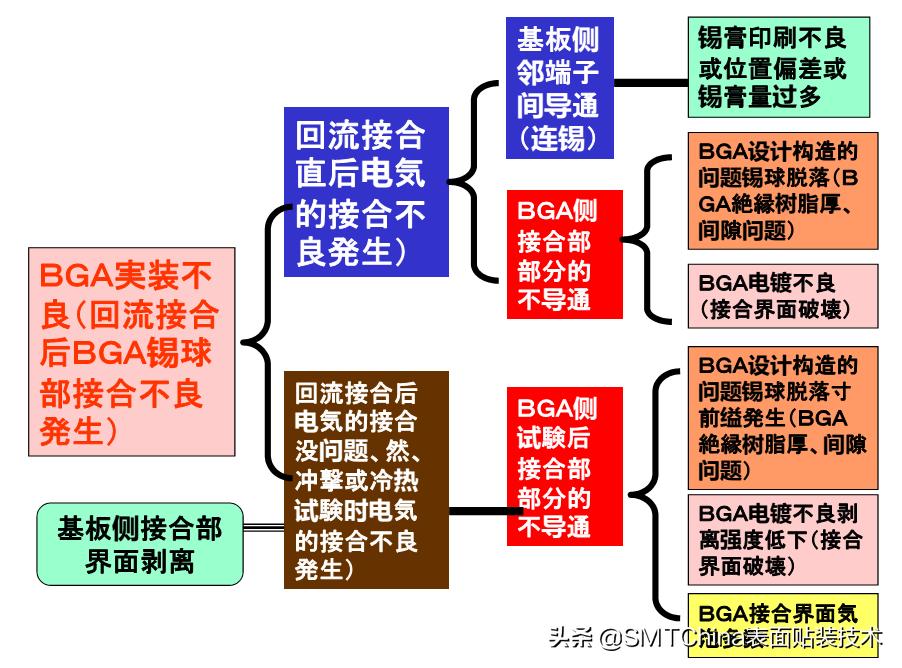
6.CSP实装不良:锡球脱落及変形现象解说(事例1)
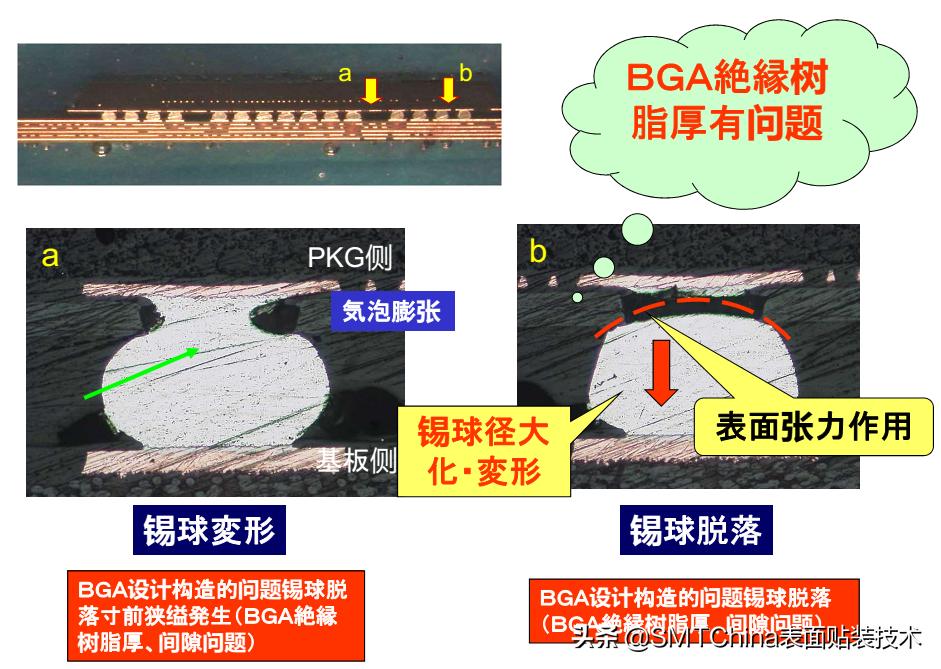
7.CSP实装不良:锡球脱落及変形现象(事例2)
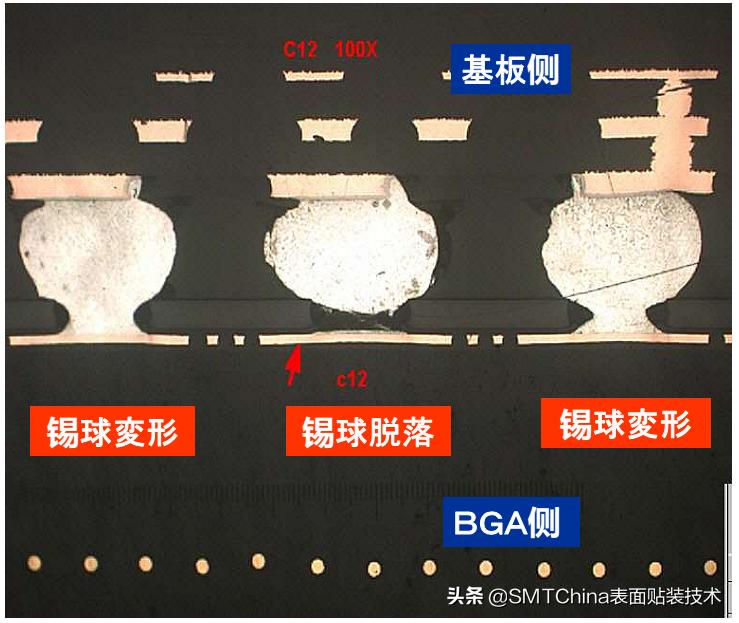
CSP实装不良:锡球脱落及変形现象(事例3)
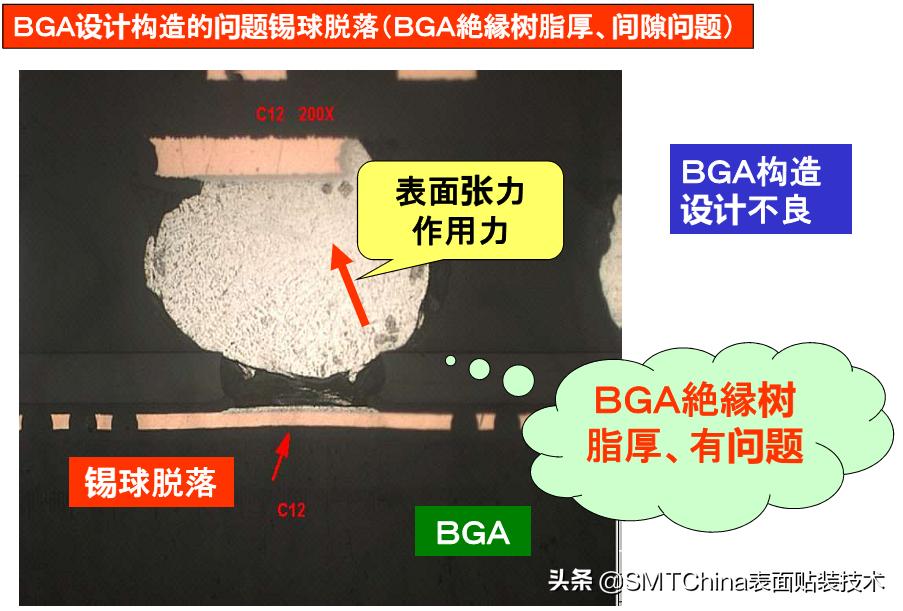
8.CSP、BGA实装不良:锡球脱落及変形现象解说
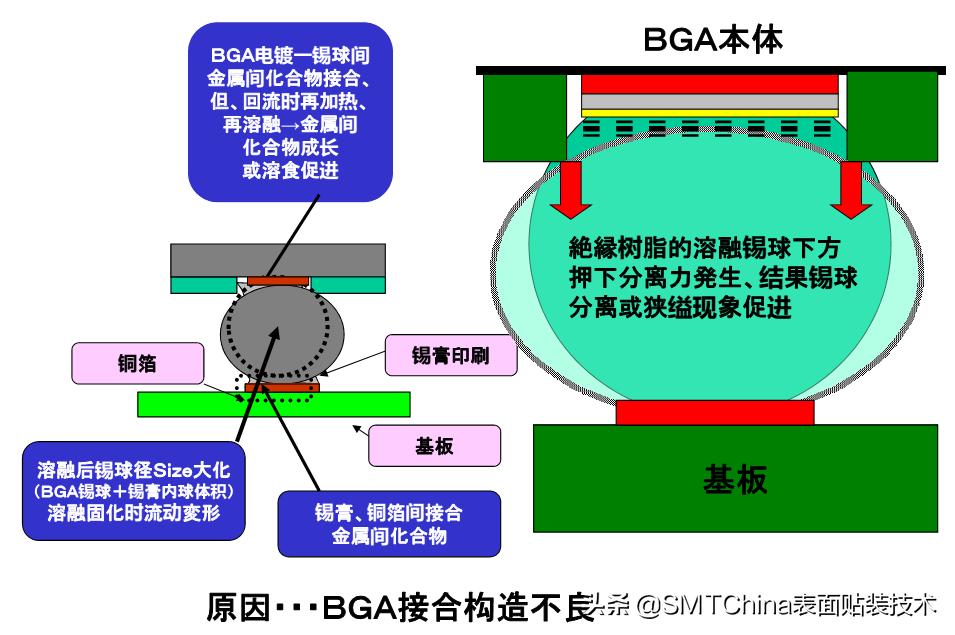
9.CSP、BGA実装不良:金属间化合物相界面剥离(1)
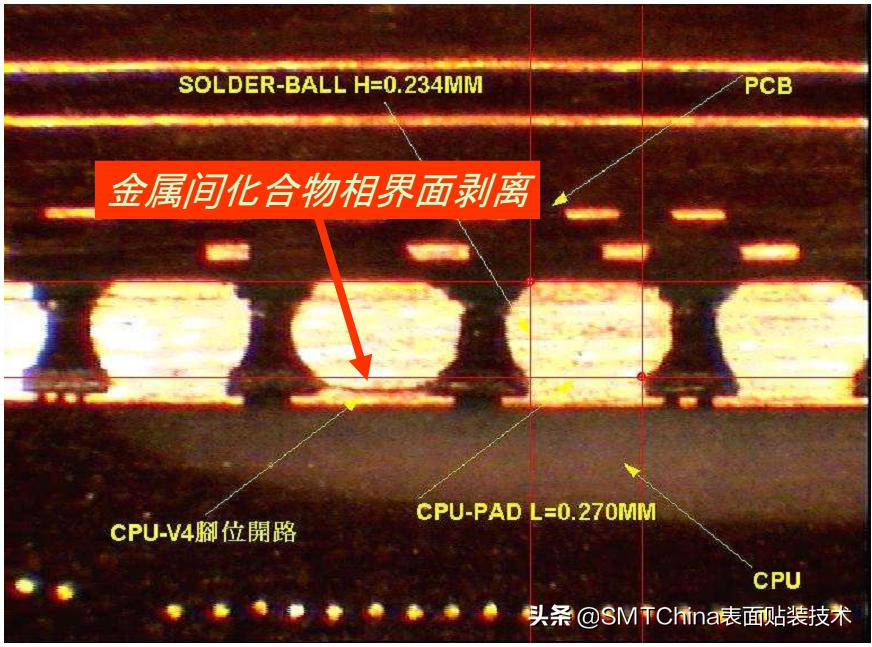
10.CSP、BGA実装不良:金属间化合物相界面剥离(2)
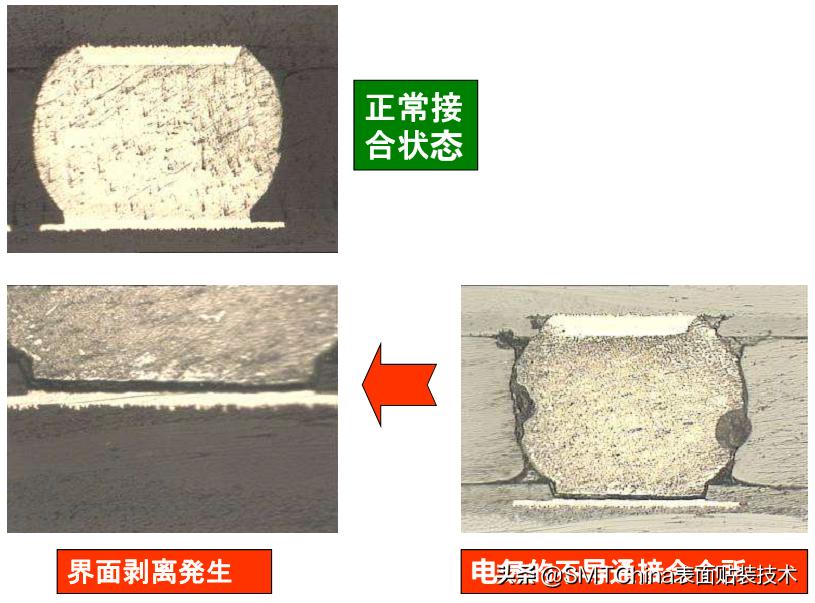
11.CSP、BGA実装不良:金属间化合物相界面剥离(3)

12.锡球脱落及变形现象、对策方法

13.锡球接合界面破坏现象、对策方法

2、电镀问题
1.锡球接合界面破壊现象、Ni电镀问题

锡球接合界面破壊现象、Ni电镀Cl污染问题(污染组成构造)

3.锡球接合界面破坏现象、Ni电镀污染ー接合力低下现象

4.錫球接合界面破壊現象、Au/Ni-P電鍍諸条件影響問題
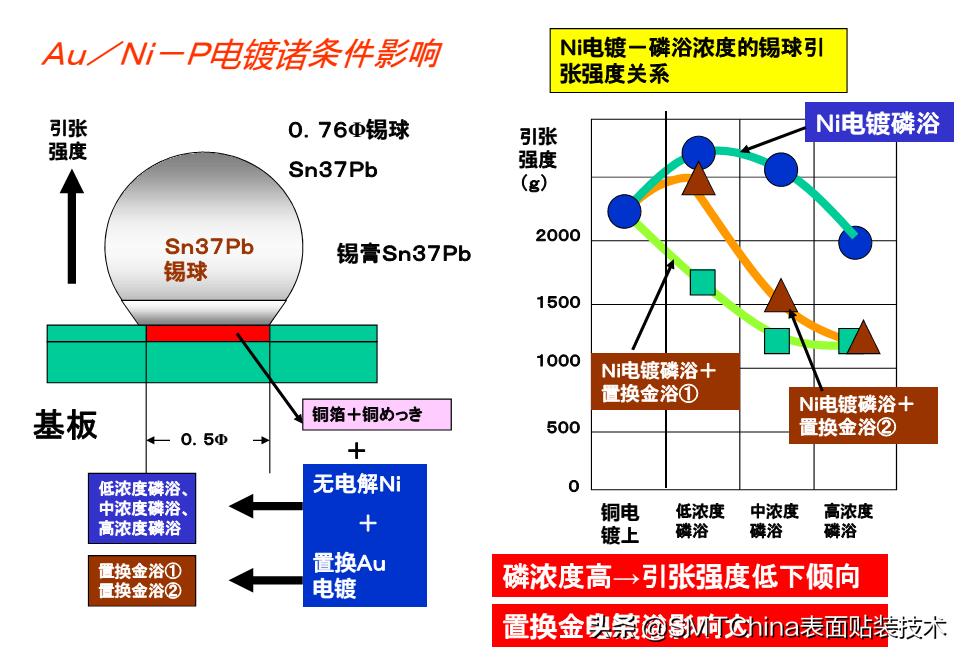
5.Au/Ni-P電鍍諸条件影響問題-無電解電鍍条件

6.Au/Ni-P電鍍諸条件影響問題-置換金電鍍浴浸漬時間影響

7.錫球接合界面破壊現象、Sn-Cu接合界面合金厚ー接合強度
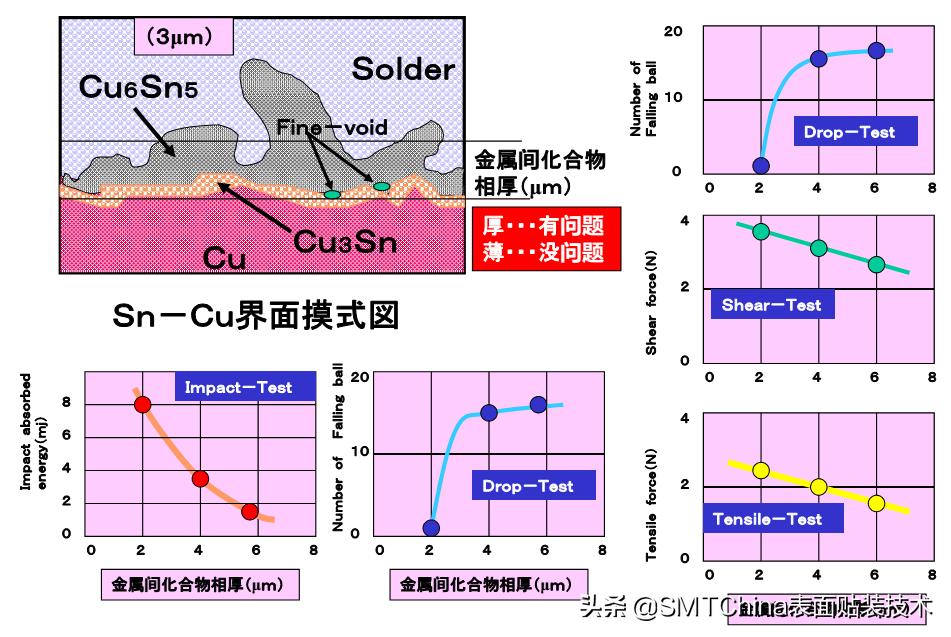
3、CSP (BGA)气泡问题
1.气泡发生原因
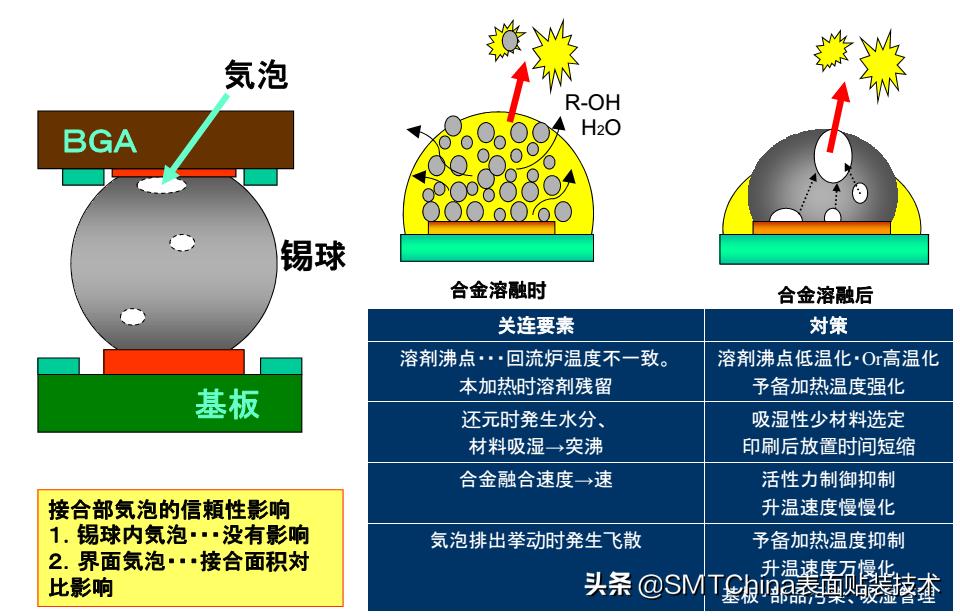
2.CSP(BGA)实装时发生气泡分析~錫球組成+錫膏組成変化・・・回流接合挙動相違点 ~
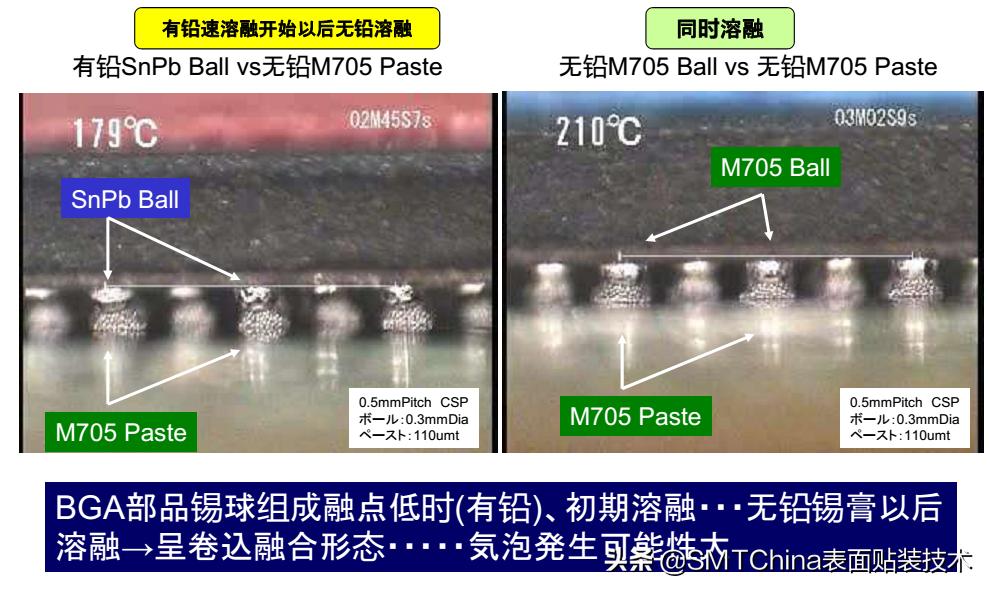
3.CSP(BGA)实装时发生气泡分析
~錫球組成+錫膏組成変化・・・回流接合挙動相違点~
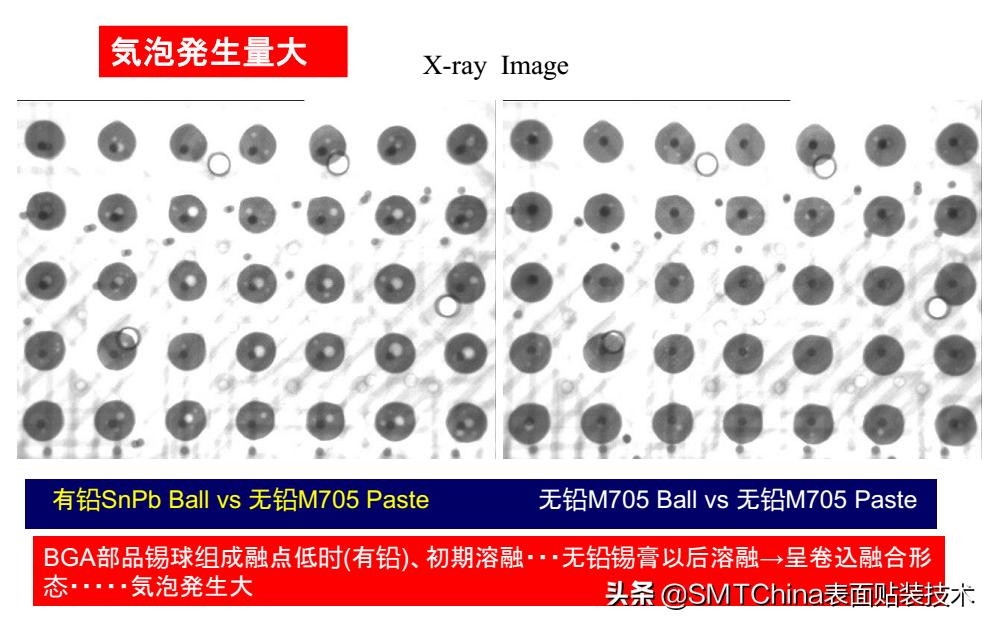
4.錫球組成+錫膏組成変化
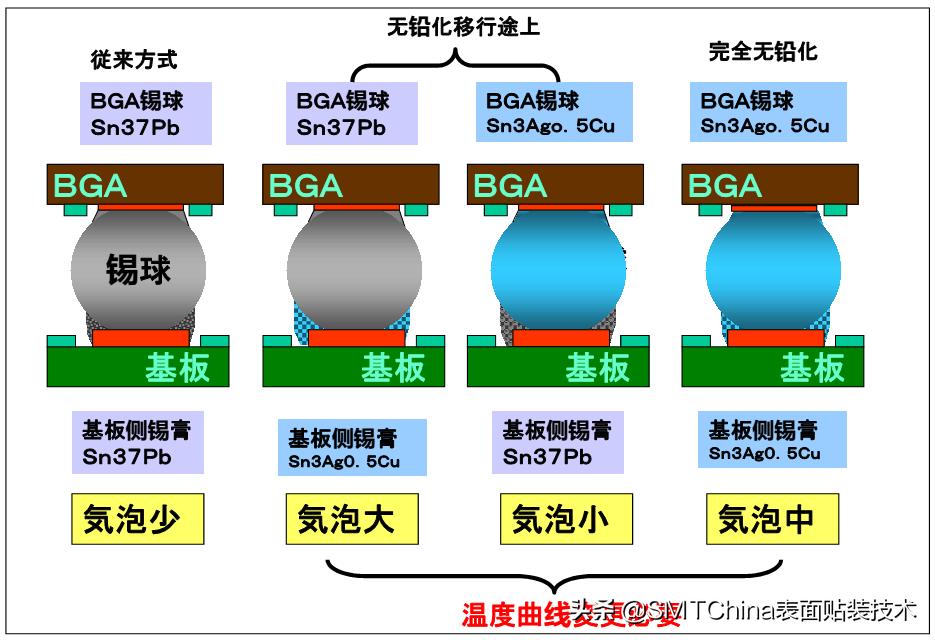
4、相关连技术
1.CSP(BGA)錫球脱落問題参考資料 錫ー金溶食速度(1)
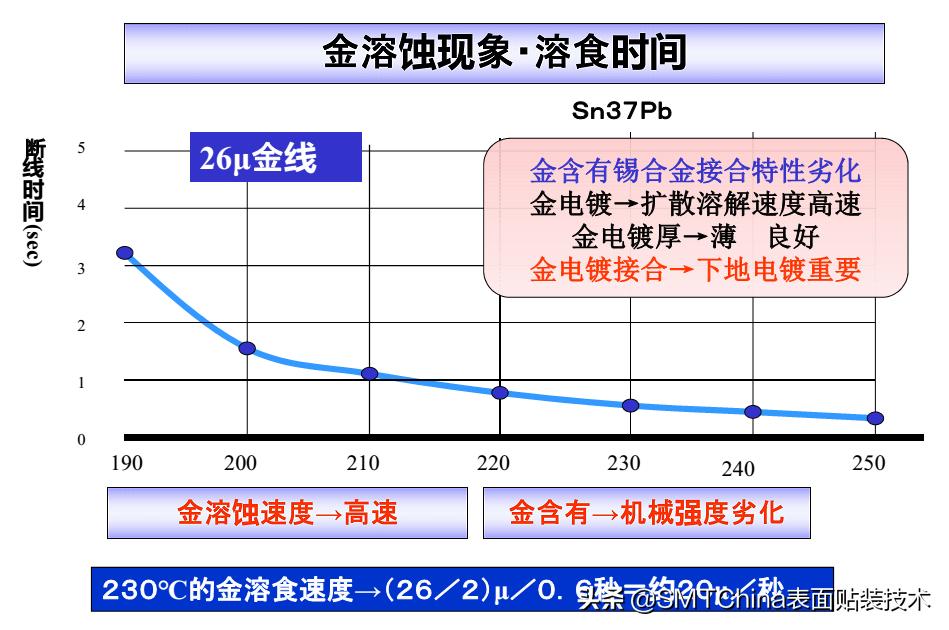
2.CSP(BGA)錫球脱落問題参考資料 錫ー金溶融温度变化(2)
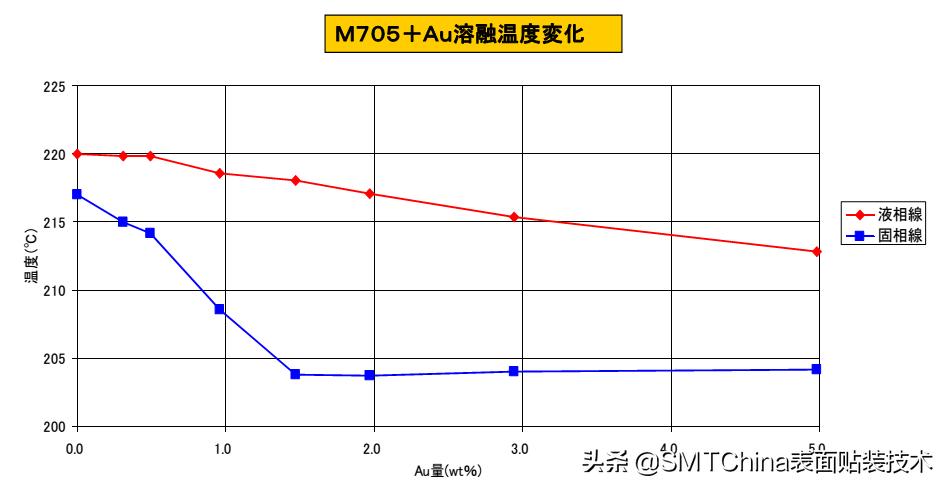
3.CSP(BGA)錫球脱落問題参考資料 金浓度ー強度関係
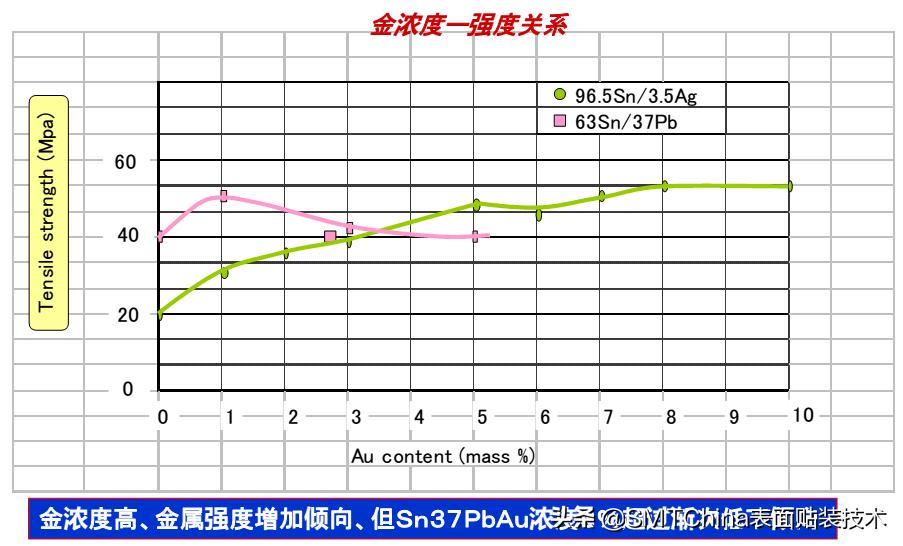
4.CSP(BGA)錫球脱落問題参考資料 金濃度ー伸長関係
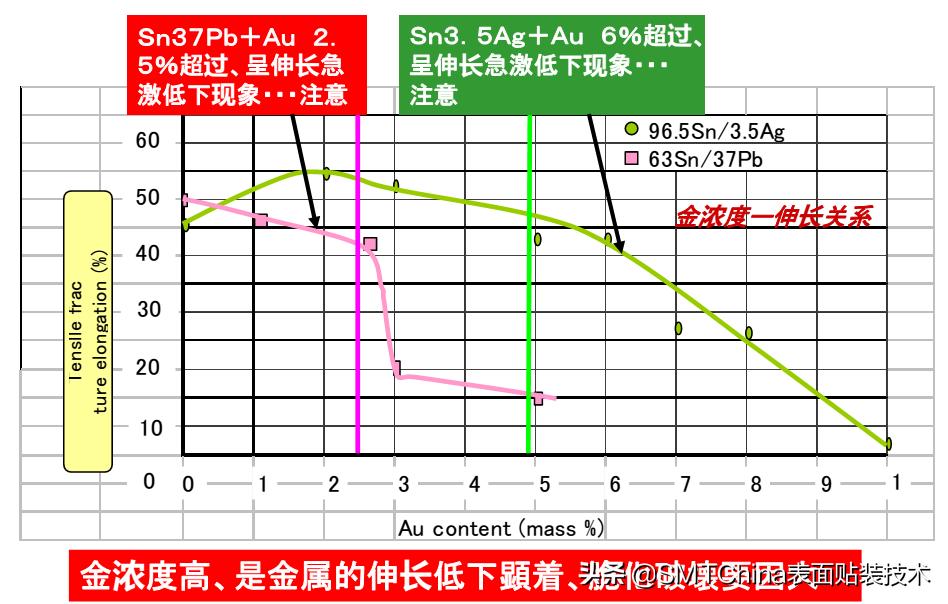
5.CSP(BGA)錫球脱落問題参考資料 錫膏印刷厚ー金濃度的関係
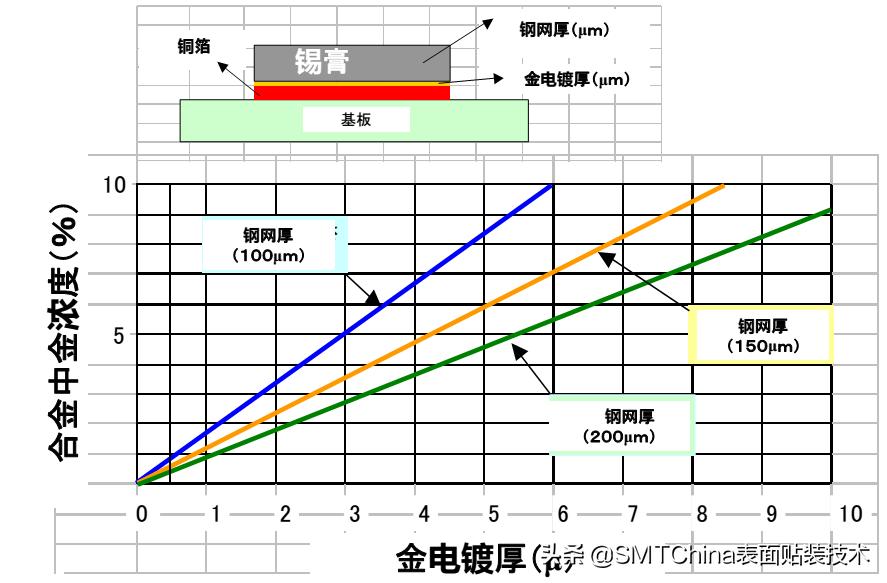
CSP(BGA)錫球脱落問題参考資料 金属間化合物(1)

6.CSP(BGA)錫球脱落問題参考資料 金属間化合物
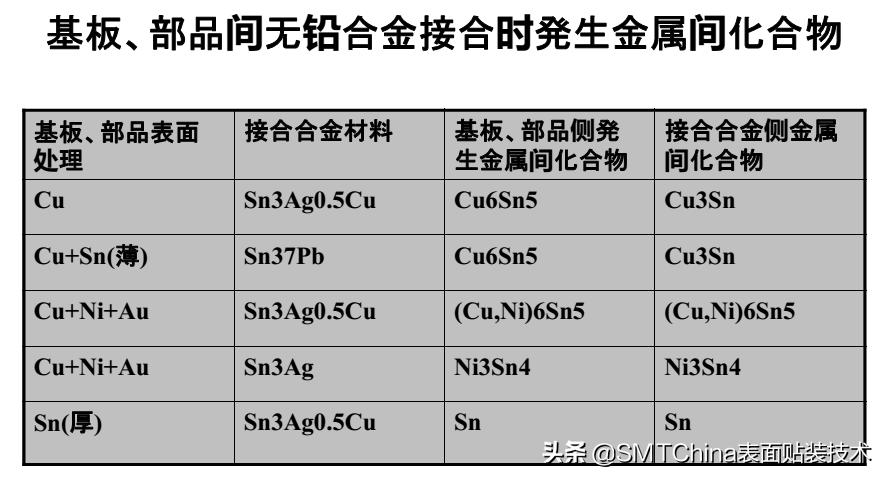
7.SMT不良事例.混載実装界面剥離現象及対策
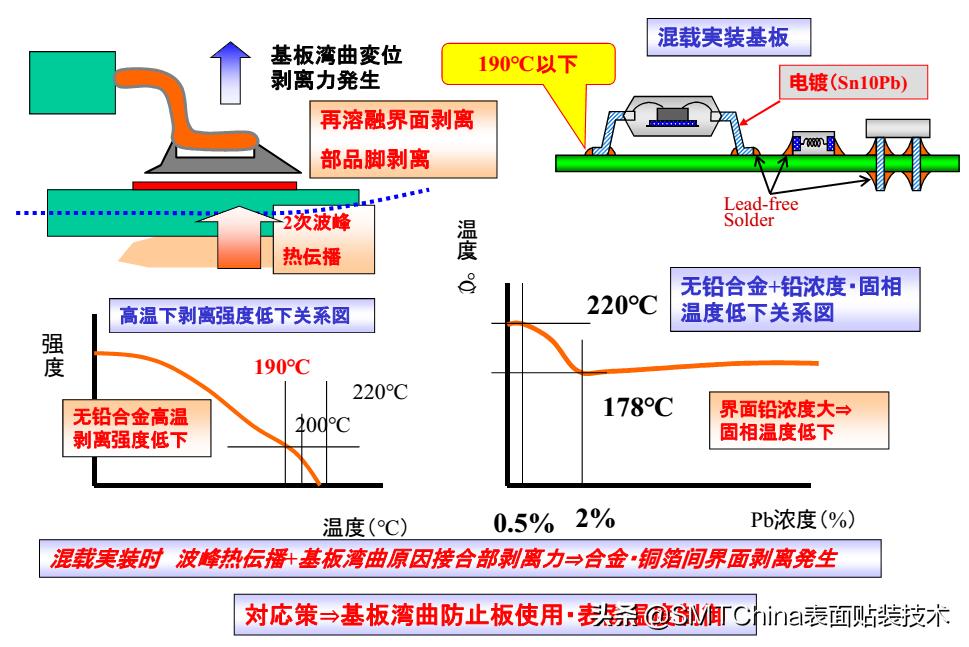
8.SMT不良事例 ex:脚部界面剥离原因・对策
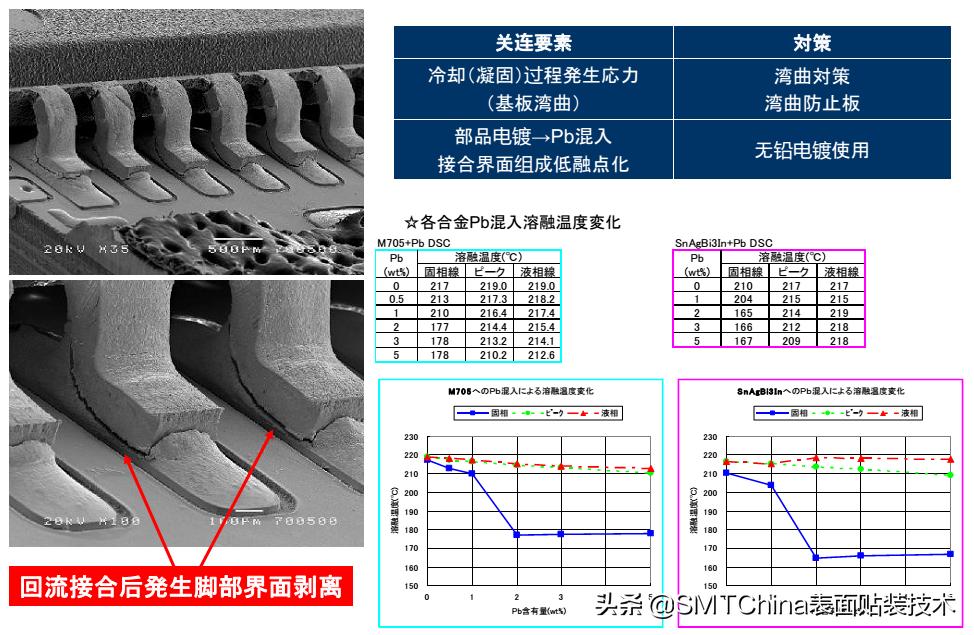
9.SMT不良事例 .銅箔剥離現象及对策

5、SMT接合工法・回流温度曲线
SMT回流焊就是通过大量加热,使锡膏受热融化从而让表面贴装元器件和PCB焊盘通过焊锡膏合金可靠地结合在一起的制程。
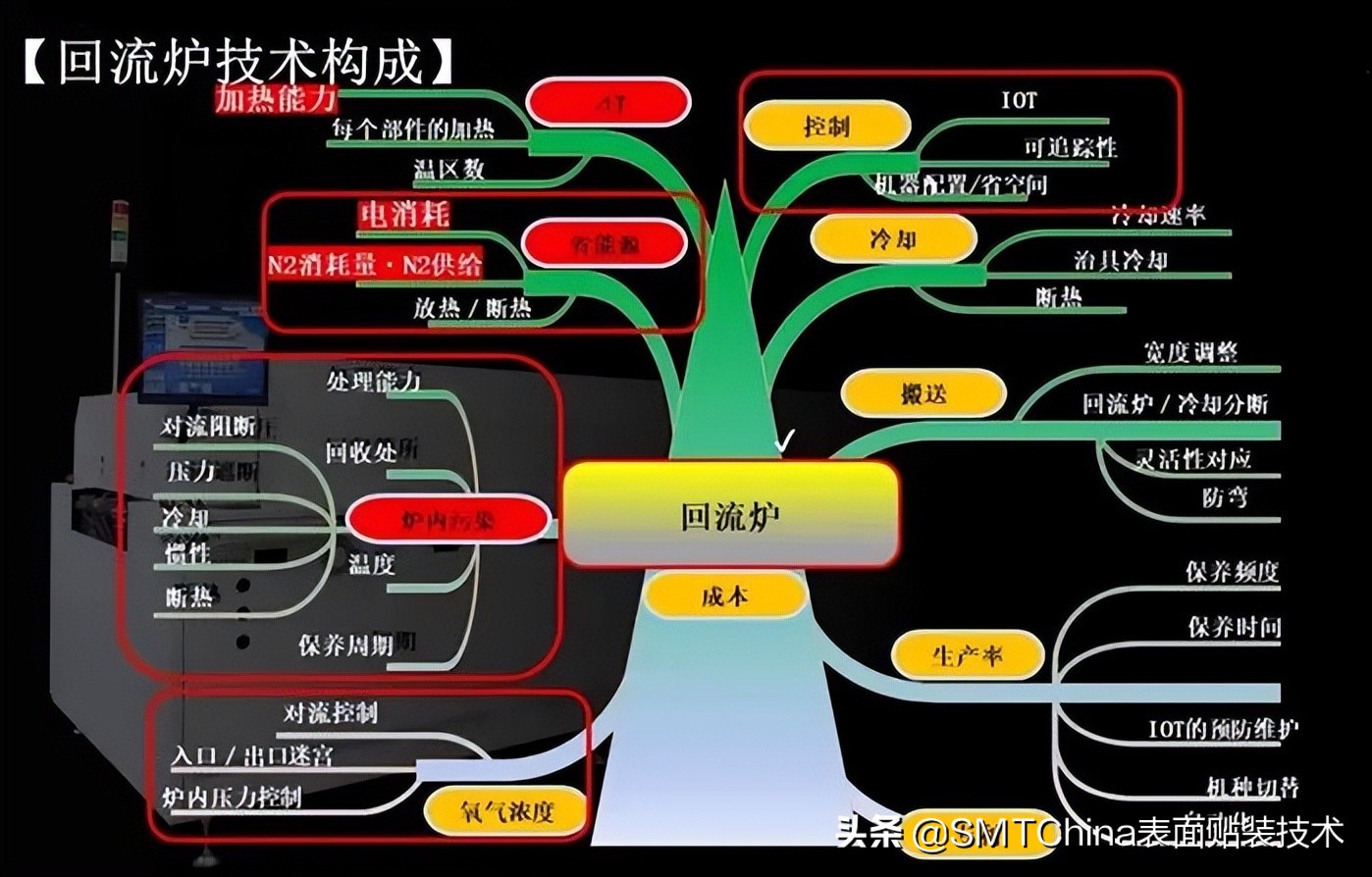
焊接前,表面贴装元件依靠一定量的锡膏的粘性被固定在表面,合金焊料融化后,通过润湿作用附着在金属表面,冷却固化后,在PCB 和元件之间创建一种机械和电器的连接。
SMT回流焊接BGA未融合的要因

1.有鉛、無鉛 錫膏(回流機)温度余力比较
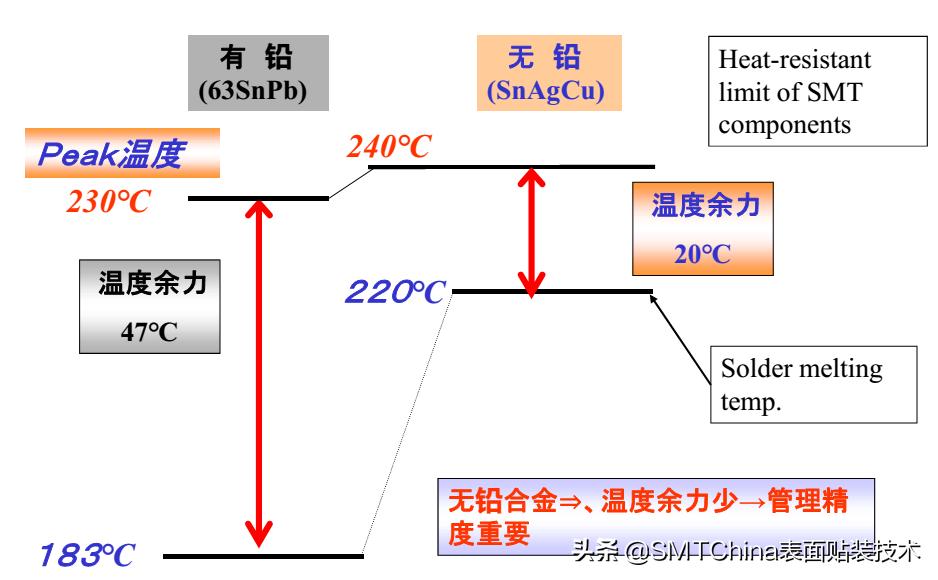
2.回流焊炉温度曲线
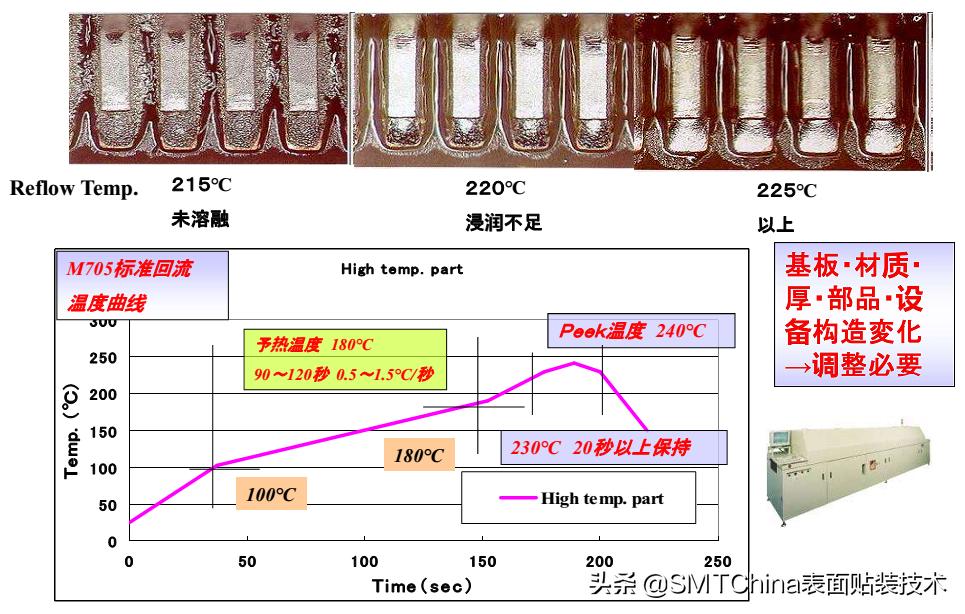
3.回流温度溶融域条件設定
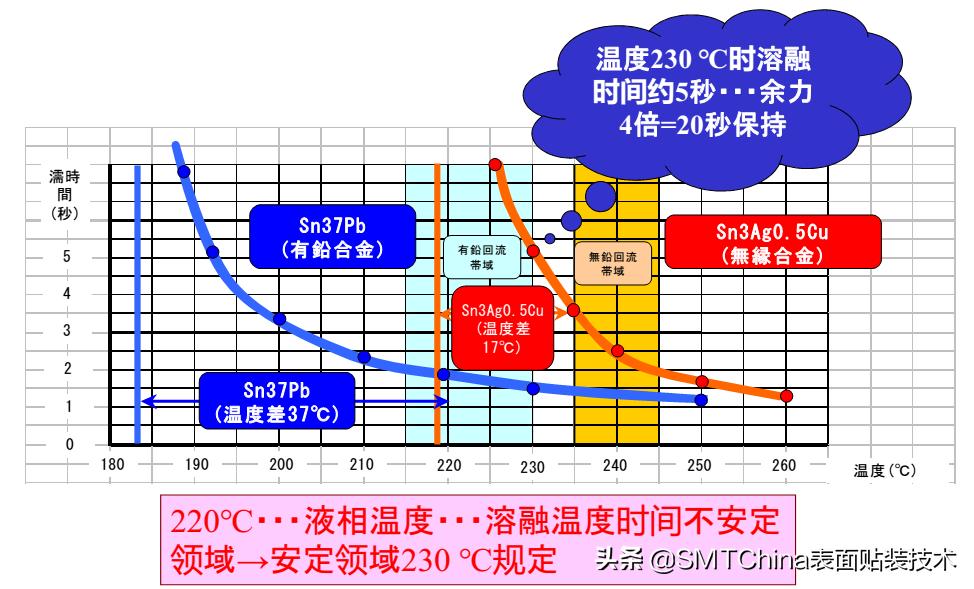
4.他SMT不良事例:接合合金・未溶融
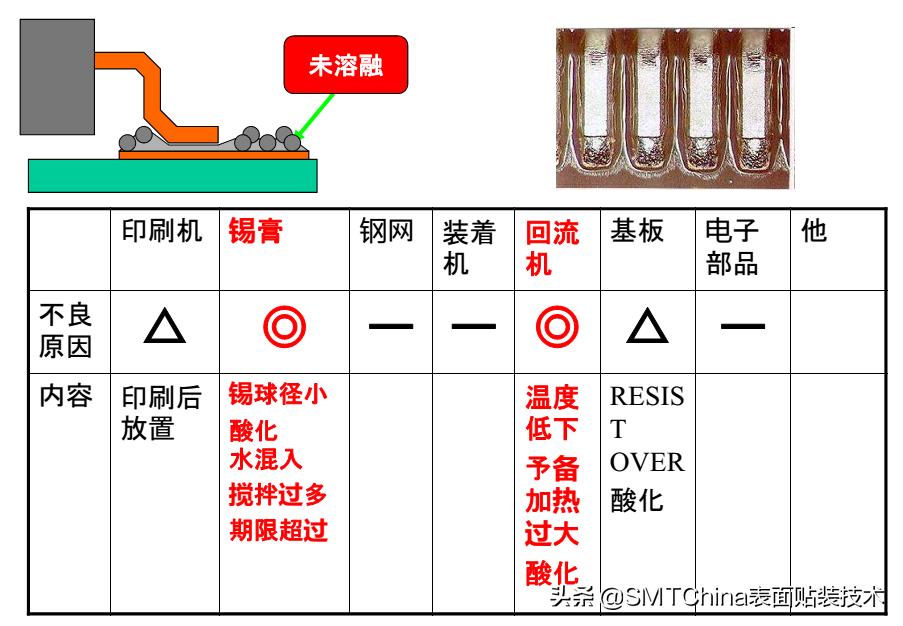
5.他SMT不良事例:连錫

6.他SMT不良事例 ex:錫膏连錫原因
HOT Slump Test 高温长時間 Slump发生大
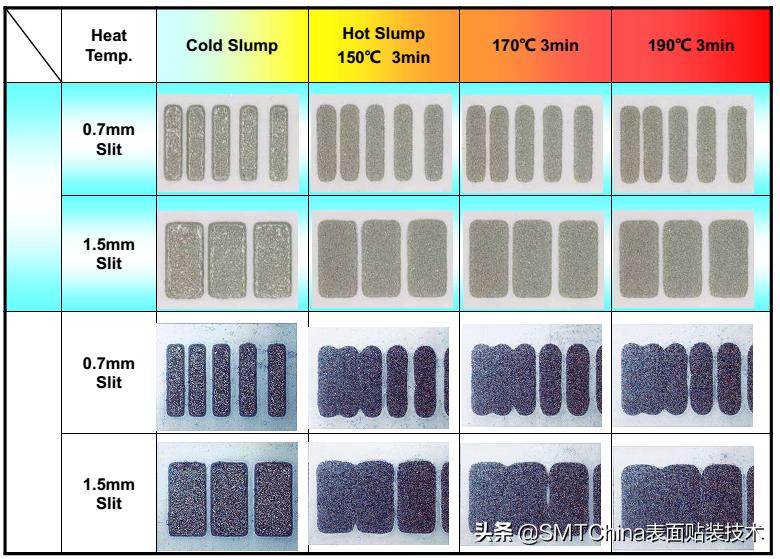
7.他SMT不良事例:錫球・FLUX飞散

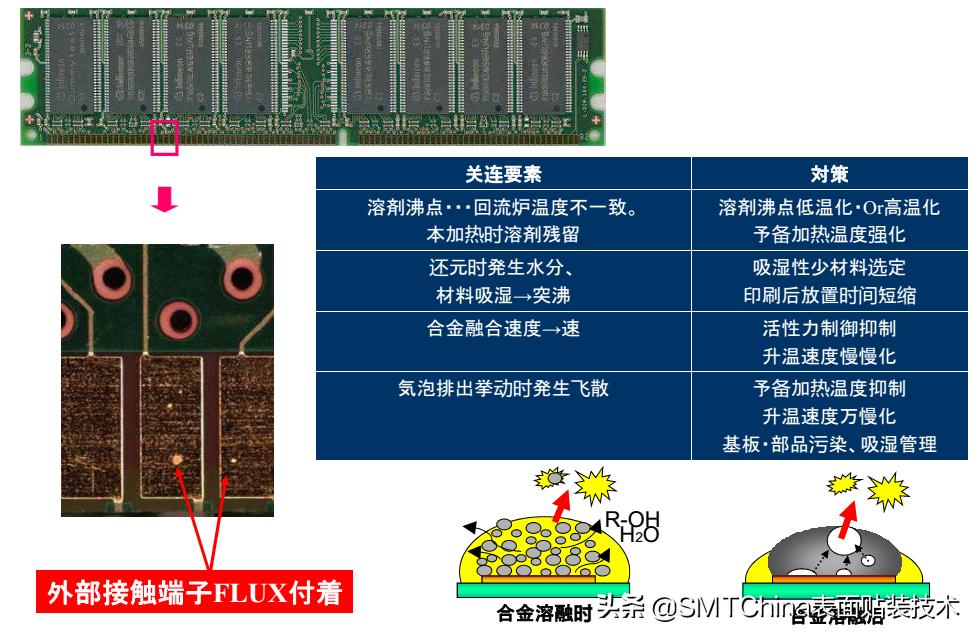
8.他SMT不良事例:錫珠・錫球対策
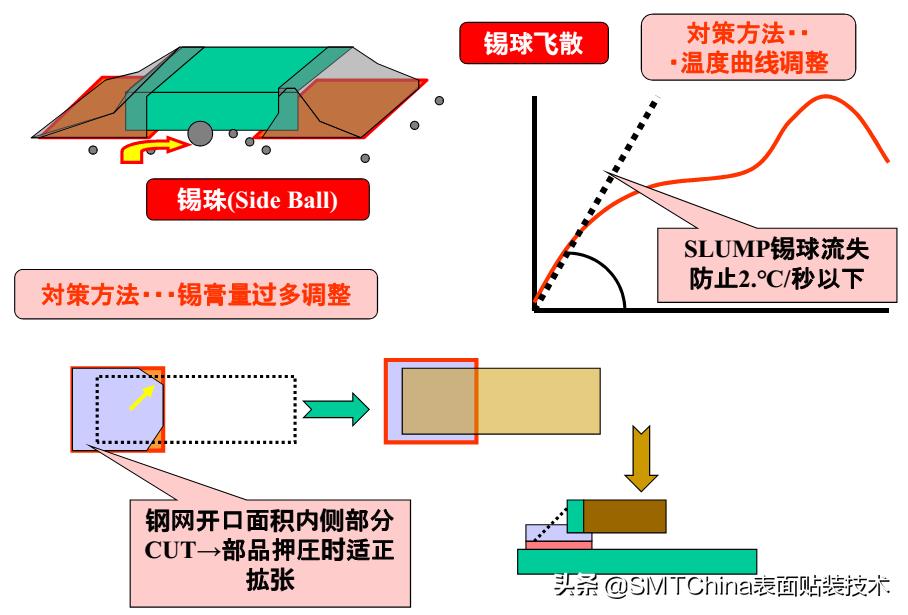
9.他SMT不良事例:De Wetting现象対策
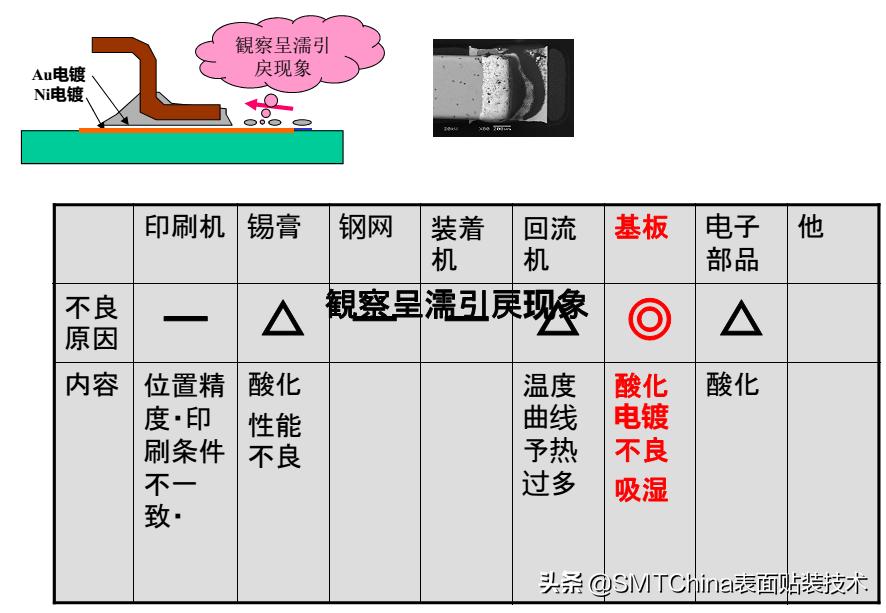
10.他SMT不良事例:IC脚先端部濡不良対策例
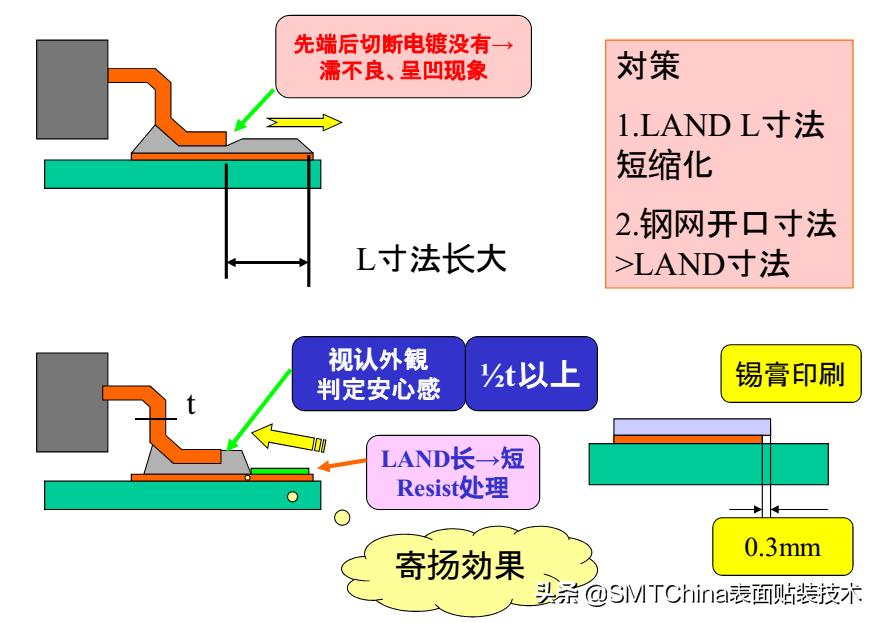
11.他SMT不良事例:CHIP部品电极下气泡

12.他SMT不良事例:FLUX残渣中气泡
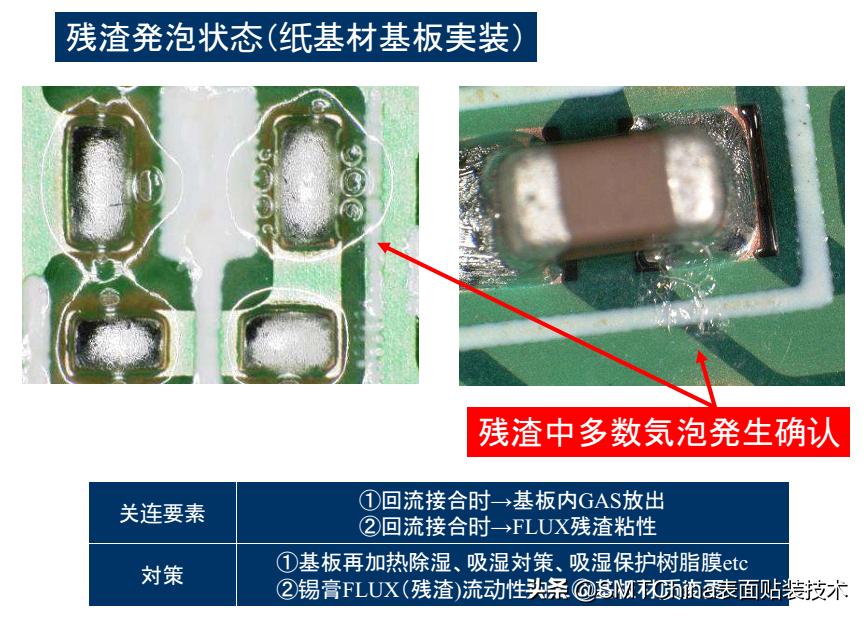
13.他SMT不良事例:De Wetting现象・対策
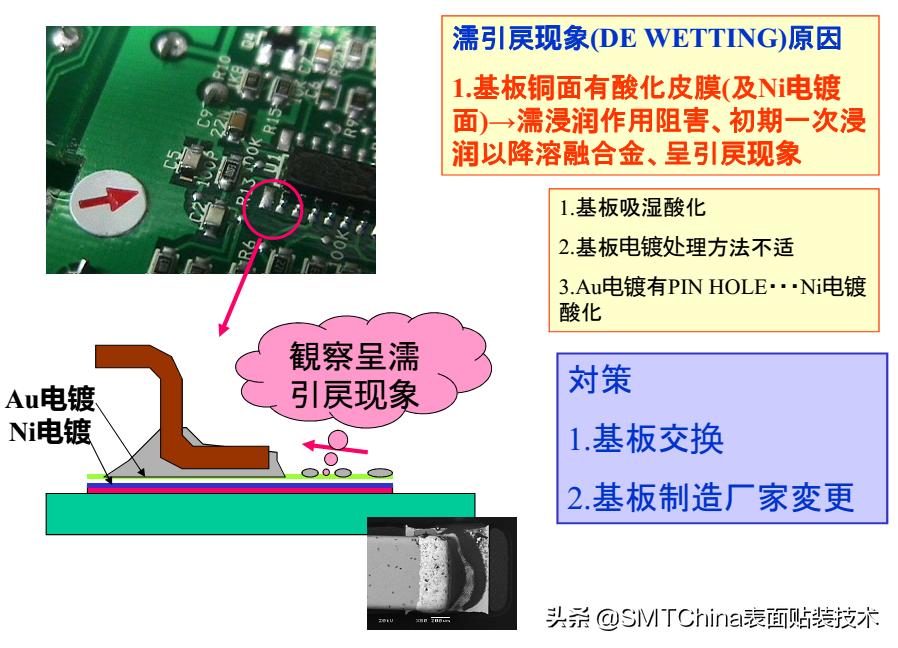
14.他SMT不良事例:电鍍不良起因CHIP部品接合強度不足
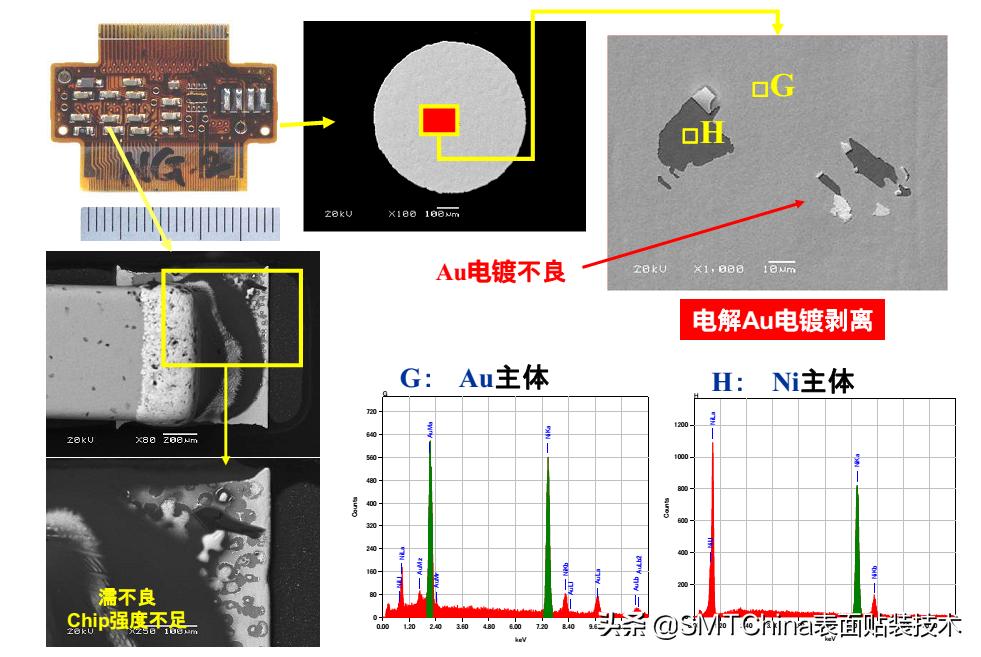
15.他SMT不良 金电鍍変色現象、対策方法
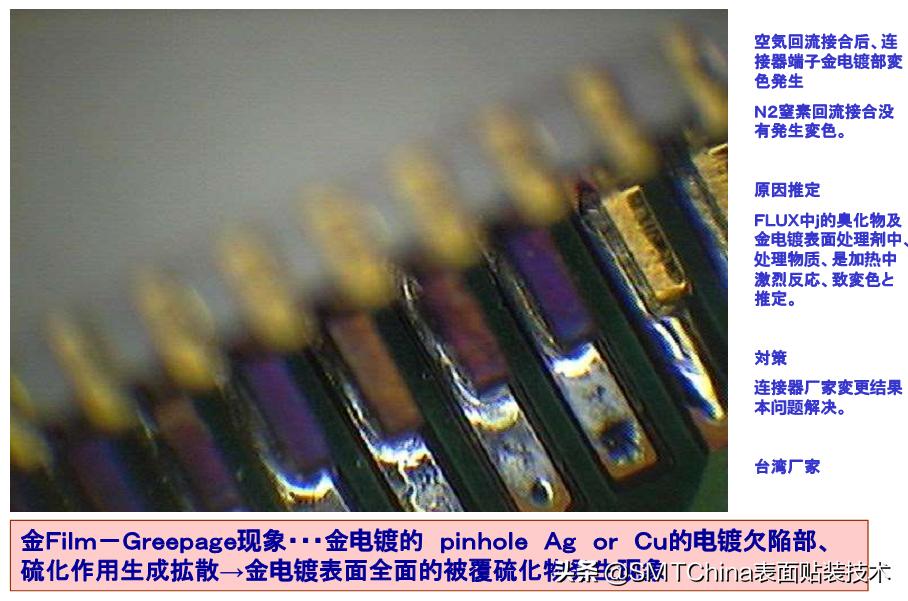
16.無鉛合金接合不良对策 結論(1)

17.無鉛合金接合不良对策 結論(2)
