--我们从哪里来?又到哪里去?
2003年长*光春**机所:球面Schwarzschild物镜
故事再次回到20年前:
彼时,后来的科技部副部长、02专项光刻机工程指挥部总指挥 曹健林教授 仍是长*光春**机所研究员、博士生导师。曹健林教授的一位博士生 金春水 ,也就是后来02专项“极紫外光刻关键技术研究”项目的负责人,于 2003年 发表的博士学位论文 《极紫外投影光刻中若干关键技术研究》 (图1)。

图1:金春水博士的学位论文《极紫外投影光刻中若干关键技术研究》
金春水博士的学位论文,水准很高,其核心内容是(图2,图3):
1,设计了缩微倍率为10倍的 球面Schwarzschild物镜 作为EUV原理装置的缩微投影物镜;
2,集成了一套EUV原理装置,并且在 国内首次获得了0.75微米线宽 的EUV复制图形。

图2:金春水博士论文的摘要部分

图3:金春水博士论文的主要章节
请大家一定要记住 球面Schwarzschild物镜, 因为这是中国未来20年EUV光刻机的种子。那么什么是 球面Schwarzschild物镜 呢?其实这是一个如图4所示的简单的双镜头的反射式投影系统:图中M1和M2是EUV的反射式镜头。

图4:一个简单的球面Schwarzschild物镜微缩镜头,其核心是M1和M2双镜头
球面Schwarzschild物镜 系统可以说是近代EUV光刻机早期研究的实验系统,可以追溯到上世纪80年代:
* 1986年 ,日本NTT公司利用1/8倍的Schwarzschild物镜,完成了二维 2um线宽 的光刻复制,工作波长是12.5nm;
* 1989年 ,日本NTT公司利用同一系统成功地复制出 0.5um线宽 的线条,
* 1990年 ,美国AT&T公司利用1/20倍的Schwarzschild物镜复制出 0.05um线宽 的线条,工作波长为14nm。
* 1992年 ,日本NTT公司完成可复制 0.15um线宽 的图形。
所以,我们可以清楚地了解到,金春水博士的学位论文,当时代表了国内最好的水平之一,完成的是上世纪九十年代日本和美国的关于 双镜头球面Schwarzschild物镜系统的早期研究。
2003年美国EUV光源工程测试台: Engineering Test Stand (ETS)
彼时,在2003年金春水博士完成他的国内首套基于 双镜头球面Schwarzschild物镜系统 的研发系统的博士论文的节点,美国组织了一只庞大的科研系统团队完成了EUV光刻机商业化进程的关键三年之战:发表全球首套 EUV光源工程测试台(Engineering Test Stand,ETS) 的研发、测试工作。这个庞大的团队包括了:美国圣地亚国家实验室、美国劳伦斯利弗莫尔国家实验室、英特尔、摩托罗拉、英飞凌、ASML等。

图5:ETS平台参与的部分单位
其三年的工作节点包括:
* 2000年7月21日 ,在一篇长达22页的论文中公布了ETS平台的设计详情;

图6:2000 发布EUV ETS平台
* 2002年 ,发布了ETS首测结果,我们可以注意到ASML已经参与此次测试工作;

图7:2001发布 EUV ETS初测
* 2002年 ,完成初步的光刻评估,EUV大局已定。

图8:2002年发布基于ETS平台的EUV光刻评估结果
那么这个ETS平台到底是什么呢?
首先这是一个已经抛弃了早期的 2镜头球面Schwarzschild物镜 系统,升级到 4物镜的EUV光学系统 (图9)。这是一个非常重要的技术演化,已经非常接近现在商用化的6镜头EUV光学系统。

图9:ETS的4物镜EUV光学系统示意图
其次,该系统 演示了所有EUV光刻机的组件和子系统 (图10):包括光源源室和主曝光室。ETS包括大约100个传感器,包括温度、振动、通量和源位置传感器;透过镜头成像仪;孔径观察传感器;刻线剂量传感器阵列;晶片剂量传感器;航空图像监视器等。
小伙伴们看看图10,这是不是已经非常接近于现代商业化EUV光刻机的一个雏形了呢?

图10:ETS整体结构图
美国的ETS团队给出的 两个目标 :
1,评估包括所有当前商业化EUV光刻机的重要问题(图11);
2,提供用于EUV产业链开发的基本EUV工具(图12)。

图11:ETS平台的核心目标是评估包括所有当前商业化EUV光刻机的重要问题

图12:ETS平台的第二个重要目标是用于EUV产业链开发的基本工具
至2003年(图13),美国人长舒一口气:“ ETS,No surprise(我们搞定了) ”!
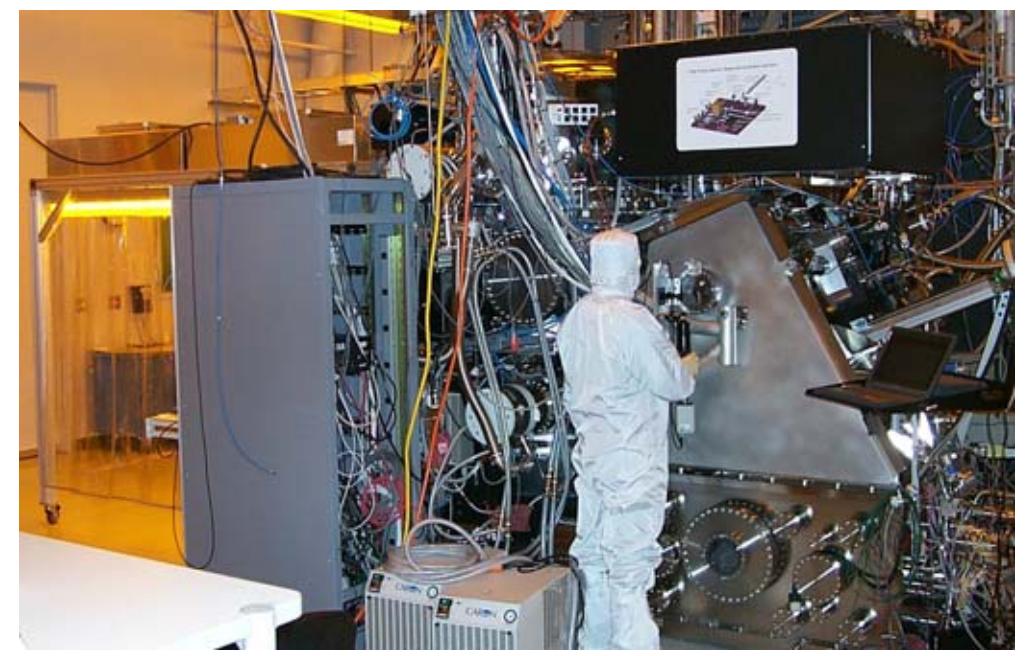
图13:ETS平台工作现场,No Surprise!
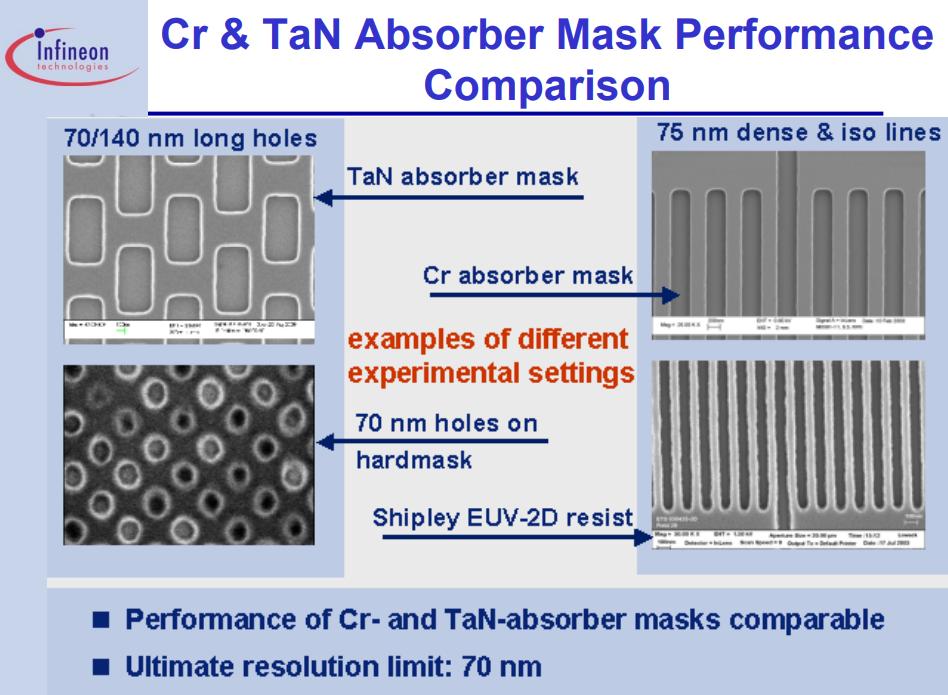
图14:英飞凌用ETS平台实现70nm线宽
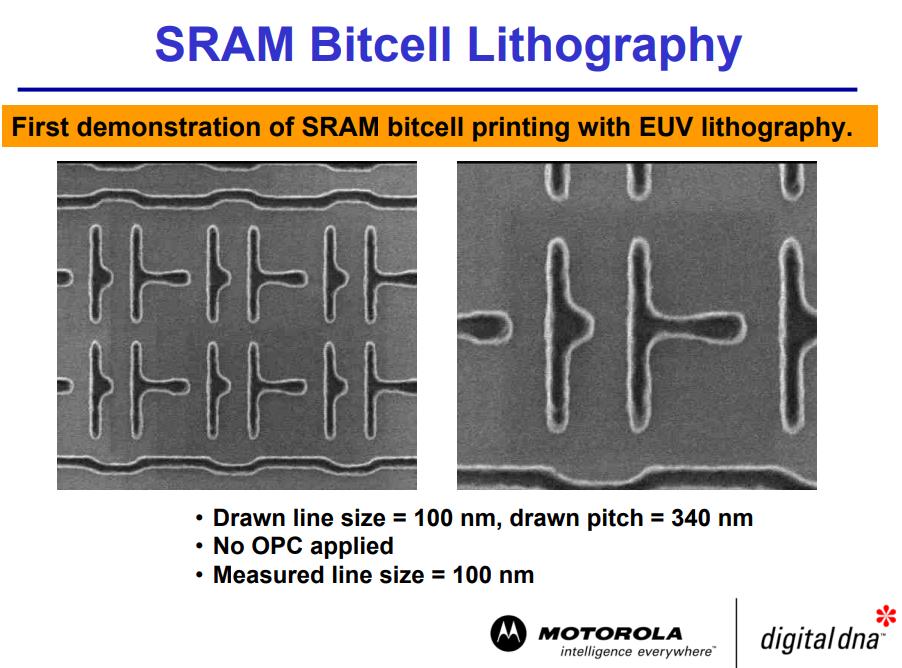
图15:摩托罗拉用ETS平台实现100nm线宽
2003年日本尼康
彼时,日本光刻机巨头 尼康 正雄心勃勃地与ASET财团合作,计划在 2006年完成一个完整的现场测试系统 ,早在2008年就有一个生产工具。目标规格是这样的机器能够打印45 nm线和空间(1/2节距)。吞吐量应为60至80晶圆/小时(300毫米晶片)。当然,此计划假定光源源、光刻胶和掩模等基础设施的可用性。
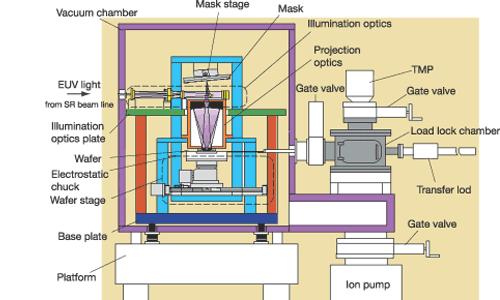
图16:日本尼康的EUV验证机设计图
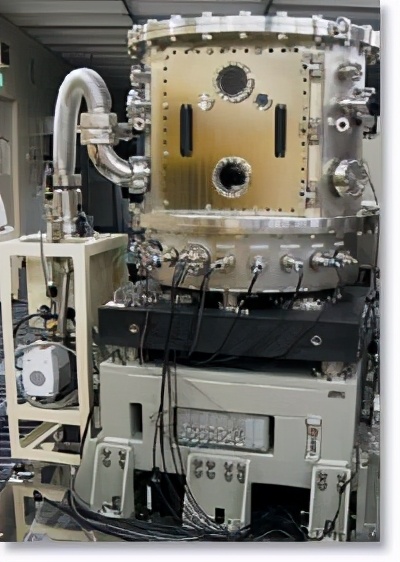
图17:日本尼康的小场曝光系统已经证明了EUV光刻的概念.
幸运的是,尼康早期大部分开发工作从 电子投影光刻(EPL)项目可以转到EUV光刻发展 。工作在真空中,空气引导晶片和刻板级;晶片卡盘;晶片和刻线装载机和真空负载锁;抑制不需要的材料真空排气系统;全真空系统,热设计和控制;辅助控制电子和软件都可以直接适应EUV系统的工作。 尼康甚至已经开始设计基于6镜头的光学系统。
2003年日本佳能
彼时,日本另一光刻机巨头厂商 佳能 ,也在计划开发一系列EUV光刻工具,用于在45 nm技术节点及更远的地方进行高容量制造中的关键层图案化。 佳能的发展路线图要求在2005年底前推出测试版工具 ,并在2007年推出生产工具。
佳能,自上世纪80年代初以来,一直致力极端紫外线(EUV)光刻研究,当时所面临的技术挑战似乎是无法克服的。和尼康一样, 佳能早期研发x射线光刻程序的一部分核心技术直接适用于EUV光刻。 佳能将适应许多EUV平台的特点,如其真空兼容的高速300毫米空气轴承晶圆级;晶片和网线负载锁;热管理;非球面抛光;高精度表面处理;以及环境控制进入其未来的EUV工具平台。
制造生产级EUV光刻机需要一个重要的基础设施, 高精度抛光,涂层,和测量工具 。因此佳能开发了一系列的高精密设备:
1,高精度的反射率测量:佳能公司开发了一种 带有小型激光等离子体电子紫外线源的反射仪 。对多层光学特性的精确评估要求用这两种方法测量反射率。 s -极化( R s)和 p -极化( R p)光。佳能的系统包括一个旋转的,可伸缩的偏振器,它允许在测量样品时方便地切换极化条件。偏振器包括三个多层反射镜,以保持入射光束和输出光束的光轴在一条直线上。
2, 内置的光束监视器将反射计的EUV光源的不稳定性降低到小于0.1%。 其他工具功能包括一个有五个自由度的卡盘运动样本和一个八个样本的杂志。将在2003年年中安装一个大型舞台和腔室,以容纳全尺寸镀膜投影光学反射镜。
3, 曝光波长上进行计量的能力对于EUV光刻工具的制造至关重要。佳能计划 开发一种EUV波前计量系统,该系统可用于制造用于EUV曝光工具的六反射镜高数字孔径投影光学 。
2016年长*光春**机所
2016年7月4日长*光春**机所报道02专项现场验收中提到:
中科院长*光春**机所自上世纪九十年代起专注于EUV/X射线成像技术研究,着重开展了EUV光源、超光滑抛光技术、EUV多层膜及相关EUV成像技术研究,形成了极紫外光学的应用技术基础。 2002年,研制国内第一套EUV光刻原理装置,实现了EUV光刻的原理性贯通 。
大家都知道了,这就是金春水博士学位论文中那套 二镜头球面Schwarzschild物镜EUV演示系统。
2016年7月4日长*光春**机所报道02专项现场验收中提到的8年研发攻关的成果:
1,超高精度非球面加工与检测;
2,极紫外多层膜;
3,投影物镜系统集成测试;
4,成功研制了波像差优于0.75 nm RMS 的 两镜EUV光刻物镜系统 , 构建了EUV 光刻曝光装置 ,国内首次获得EUV 投影光刻32 nm 线宽的光刻胶曝光图形。
我想聊到这里,大家从第四条的信息,应该已经大概能了解2016年02专项验收的这套 两镜EUV光刻物镜系统 是啥了吧?
结语
在了解这段波澜壮阔的EUV开发历史过程,我被无数的技术细节困惑、折磨,我试图去理解每一个参数、每一个系统的来龙去脉,但是资料和信息量太大,仍需要一点一点的剥离出来, 希望给更多的朋友展示EUV这一顶尖科技背后蕴含的科技哲学 。
最后再说一下我的一点思考:
1,庞大的复杂科技系统, 无一不是数十年如一日的积累;
2, 科学的工程组织方式 对尖端科技发展起着非常重要的作用;
3, 科研机构对于前沿技术商业化 的推动作用和 应承担的角色 是一个值得更多人思考和讨论的事情,而不仅仅是科技人员。
下次我们再聊02长*光春**机所的更多技术进展!
备注:本文所有信息均引起网络公开资料,如有误读或理解错误,敬请指正。
参考1:https://goldberg.lbl.gov/papers/Tichenor_SPIE01_ETS_paper.pdf
参考2:https://goldberg.lbl.gov/papers/Lee_SPIE4688_2002.pdf
参考3:https://digital.library.unt.edu/ark:/67531/metadc741433/m2/1/high_res_d/792716.pdf
参考4:http://euvlsymposium.lbl.gov/pdf/2003/presentations/4E%20Lee%20EUV%20Symp.pdf
参考5:https://spie.org/news/euv-lithography-update?SSO=1
参考6:http://xrm.phys.northwestern.edu/research/pdf_papers/2001/chapman_jvstb_2001.pdf
参考7:https://spie.org/news/progress-report-engineers-take-the-euv-lithography-challengeosium.lbl.gov/pdf/2003/presentations/4E%20Lee%20EUV%20Symp.pdf
参考8:https://spie.org/news/progress-report-engineers-take-the-euv-lithography-challenge
参考9:http://www.ciomp.ac.cn/xwdt/zhxw/201611/t20161130_4713258.html