半导体封装测试是指将通过测试的晶圆按照产品型号及功能需求加工得到独立芯片的过程。通常来讲,来自晶圆前道工艺的晶圆先在前段工艺(FOL)中被切割为小的晶片,然后将切割好的晶片用胶水贴装到相应的基板上,再利用超细的金属导线或者导电性树脂将晶片连接到基板的相应引脚,构成所要求的电路。然后再进行后段工艺(EOL),对独立的晶片用塑料外壳加以封装保护、塑封,以及后固化、切筋和成型、电镀以及打印等工艺。封装完成后进行成品测试,最后入库出货。
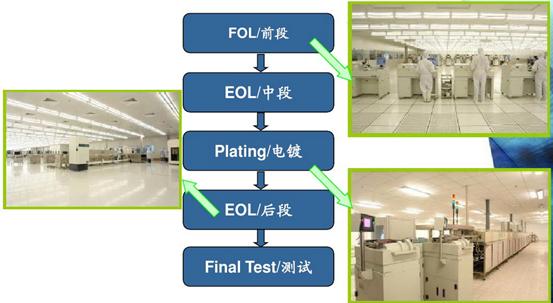
封装技术
封装的分类方式有多种,如以封装组合中芯片数目为依据可以分为单芯片封装和多芯片封装;以材料为依据可以分为高分子材料类和陶瓷类;以器件和电路板连接方式为依据可以分为引脚插入型和表面贴装型;以引脚分别为依据可以分为单边引脚、双边引脚、四边引脚、底部引脚等。封装技术历经多年发展,常见的类型有如下几种,目前行业中最常用的是SIP和WLP。
BGA (Ball Grid Arraye):球栅阵列封装,表面贴装型封装之一,是在封装体基板的底部制作阵列焊球作为电路的I/O端与PCB板互接,由美国Motorola公司开发。
CSP (Chip Scale Package):芯片级封装,该方式相比BGA同等空间下可以将存储容量提升三倍,是由日本三菱公司提出来的。
DIP (Dual In-line PACkage):双列直插式封装,插装型封装之一,指采用双列直插形式封装的集成电路芯片,体积比较大。
MCM (Multi ChipModel):多芯片模块封装,可根据基板材料分为MCM-L,MCM-C 和MCM-D 三大类。
QFP (Quad Flat Package):四侧引脚扁平封装,表面贴装型封装之一,引脚通常在100以上,适合高频应用,基材方面有陶瓷、金属和塑料三种。
PGA (Pin Grid Array Package):插针网格阵列封装,插装型封装之一,基材多采用多层陶瓷基板。
SIL (Single In-line):单列直插式封装,引脚从封装一个侧面引出,排列成一条直线。
SIP (System In a Package):系统级封装,将多种功能芯片,包括处理器、存储器等功能芯片集成在一个封装内,从而实现一个基本完整的功能。对比MCM,3D立体化可以体现在芯片堆叠和基板腔体上。
WLP(Wafer Level Packaging):晶圆级封装,是一种以BGA为基础经过改进和提高的CSP,直接在晶圆上进行大多数或是全部的封装测试程序,之后再进行切割制成单颗组件的方式。
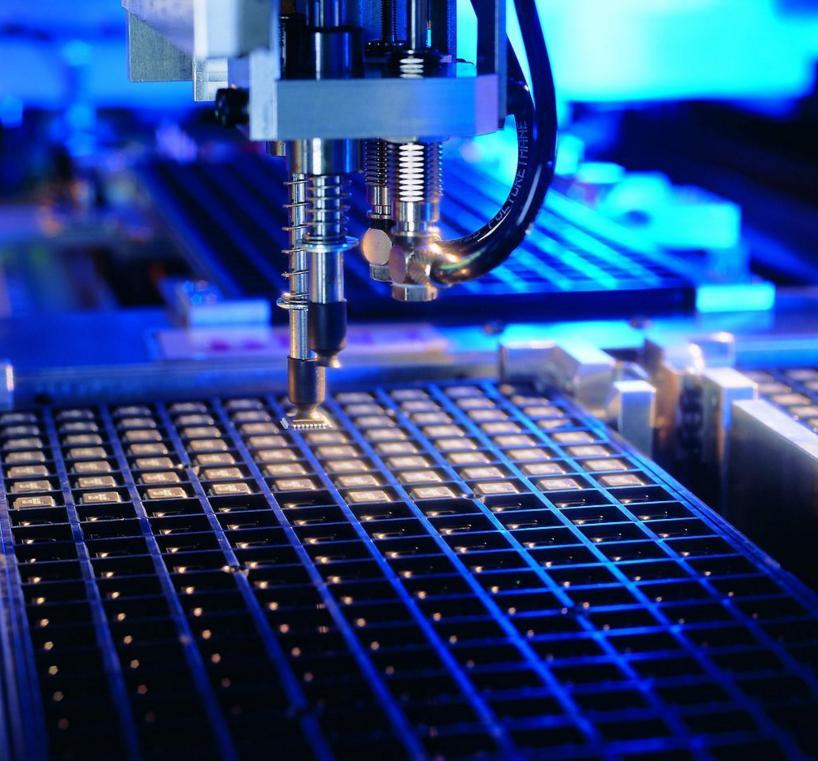
行业前景
半导体封测行业是重资产行业,成本大部分是生产设备。近年来世界其他地区增长缓慢,唯有中国地区保持高速增长。目前存储器等芯片需求旺盛,上游芯片产量增长会直接带动下游封测行业发展,而身处大陆的中国封装厂将直接受益。
封测行业主要有四家上市公司,按 2016 年营收排名分别是长电科技、华天科技、通富微电、晶方科技。
- END -
*以上内容来源于港澳资讯申港专栏。
*版权声明:若文章、图片涉及版权问题,敬请原作者联系我们。
*风险提示:投资有风险,资讯仅供参考。上述所列示涉及上市公司仅作为陈述其与该事件相关,不作为具体推荐,投资者应自主做出投资决策并自行承担投资风险。
*重要声明:本资讯中的信息、数据均来源于合法公开的信息渠道,我公司对这些信息的准确性及完整性不作任何保证。资讯所表达的观点不构成所涉证券买卖的具体建议,投资者依据上述资讯进行投资决策所产生的收益和损失,与我公司无关,我公司不承担任何法律责任。