上期我们谈了谈半导体生产中最重要的硅晶圆这个行业,这期我们将继续谈一谈其他的半导体生产过程中所必须用到的原料,即光刻胶和CMP抛光材料。

我们先了解一下光刻胶。光刻胶是光刻工艺中最关键的材料,掩模版上的图形被投影在光刻胶上,激发光化学反应,经烘烤和显影后形成光刻胶图形。光刻胶图形作为阻挡层,用于实现选择性的蚀刻或离子注入,是针对曝光波长来设计的。
光刻胶由光引发剂、树脂、溶剂等基础组分组成,又被称为光致抗蚀剂,这是一种对光非常敏感的化合物。此外,光刻胶中还会添加光增感剂、光致产酸剂等成分来达到提高光引发效率、优化线路图形精密度的目的。在受到紫外光曝光后,它在显影液中的溶解度会发生变化。
光刻胶的组份主要包括光引发剂、树脂、溶剂、光增感剂、光致产酸剂和助剂等。光引发剂吸收光能(辐射能)后经激发生成活性中间体,并进一步引发聚合反应或其他化学反应,是光刻胶的关键组分,对光刻胶的感光度、分辨率等起决定性作用。树脂是光刻胶的基本骨架,是其中占比最大的组分,主要决定曝光后光刻胶的基本性能,包括硬度、柔韧性、附着力、曝光前后对溶剂溶解度的变化程度、光学性能、耐老化性、耐蚀刻性、热稳定性等。溶剂可以溶解各组分,是后续聚合反应的介质,另外可调节成膜。单体中含有可聚合*能官**团的小分子,也称之为活性稀释剂,一般参加光固化反应,可降低光固化体系粘度并调节光固化材料的各种性能。光增感剂是引发助剂,能吸收光能并转移给光引发剂,或本身不吸收光能但协同参与光化学反应,起到提高引发效率的作用。光致产酸剂能吸收光能生成酸性物质并使曝光区域发生酸解反应,用于化学增幅型光刻胶。助剂是根据不同的用途添加的颜料、固化剂、分散剂等调节性能的添加剂。
光刻胶根据不同的方式可以分为不同的种类,如根据如何响应紫外光的特性可以分为正胶和负胶。正胶的基本聚合物是苯酚-甲醛聚合物。在光刻胶中,聚合物是相对不可溶的,在用适当的光能量曝光后,光刻胶会转变为可溶状态,这种反应为光致溶解反应,随后这一溶解部分会在显影工艺中用溶剂去掉。正胶中可能会添加抗溶解系统添加剂,防止光刻胶没有曝光的部分在显影过程中被溶解。负胶的聚合物在曝光后会由非聚合状态变成聚合状态,实际上这些聚合物形成了一种互相交联的物质,它是抗刻蚀的物质。因此在负胶的生产中,为了防止意外曝光都是在黄光的条件下进行的。负胶是最早使用的光刻胶,具有良好的粘附能力、良好的阻挡作用、感光速度快;但是显影时会发生变形和膨胀,限制了负胶的分辨率,因此一般来说负胶只用在线宽较大的领域。
图表 1正性光刻胶和负性光刻胶示意图
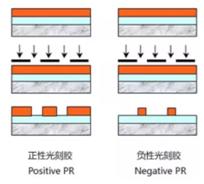
资料来源:网络资料、亨通伟德投资
按感光树脂的化学结构,光刻胶可分为光聚合型光刻胶、光分解型光刻胶和光交联型光刻胶。光聚合型光刻胶是种烯类,在光作用下生成自由基,自由基再进一步引发单体聚合。光分解型光刻胶是种叠氮醌类化合物,经光照后,会发生光分解反应,由油溶性变为水溶性。光交联型光刻胶是种聚乙烯醇月桂酸酯,在光的作用下,分子中的双键打开,链与链之间发生交联,形成一种不溶性的网状结构从而起到抗蚀作用。
按曝光波长,光刻胶可分为紫外(300~450nm)光刻胶、深紫外(160~280nm)光刻胶、极紫外(EUV,13.5nm)光刻胶、电子束光刻胶、离子束光刻胶、X射线光刻胶等。
按应用领域,光刻胶可分为PCB光刻胶、LCD光刻胶、半导体光刻胶等。PCB光刻胶技术壁垒相对其他两类较低,而半导体光刻胶代表着光刻胶技术最先进的水平。PCB光刻胶主要分为干膜光刻胶、湿膜光刻胶(又称为抗蚀刻/线路油墨)、光成像阻焊油墨等。PCB光刻胶技术壁垒相对较低,主要是中低端产品。LCD光刻胶 包含彩色滤光片用彩色光刻胶及黑色光刻胶、LCD触摸屏用光刻胶、TFT-LCD正性光刻胶等产品。彩色滤光片是LCD实现彩色显示的关键器件,占面板成本的14%~16%;在彩色滤光片中,彩色光刻胶和黑色光刻胶是核心材料,占其成本的27%左右,其中黑色光刻胶占彩色滤光片材料成本的6%~8%。半导体光刻胶包括g线光刻胶、i线光刻胶、KrF光刻胶、ArF光刻胶、聚酰亚胺光刻胶、掩膜板光刻胶等。
I-线(365nm波长)和 G-线(436nm波长)光刻胶主要成分有聚合物树脂,光敏化合物和溶剂。溶剂的增减可以改变光刻胶的粘度,从而在合理的转速范围得到所要的厚度,光敏化合物决定了光刻胶的光敏感度:在光子的作用下,光敏化合物分解,激发光化学反应,使得受光区域的光刻胶溶于显影液。KrF(248nm波长)光刻胶主要成份是聚合物树脂,光致酸产生剂以及添加剂和溶剂,聚合物树脂的分子链上悬挂有酸不稳定基团,它的存在使得聚合物不溶于显影液,光致酸产生剂是一种光敏感的化合物,在光照下分解产生酸,在曝光后烘烤过程中,这些酸会作为催化剂使得聚合物上悬挂的酸不稳定基团脱落,并产生新的酸。悬挂基团的脱落改变了聚合物的极性,有足够多的悬挂基团脱落后,光刻胶就能溶于显影液。ArF(193nm波长)主要成分有聚合物树脂,光致酸产生剂,中和光致酸的碱性中和剂,功能添加剂,添加剂会对光刻胶的性能做微调,使之能够符合特定工艺的要求。 ArF Immersion(193nm波长)浸没式光刻中,光刻胶是浸没在水中曝光的,光刻胶的有效成分中必须不溶于水,在与水接触后,光刻胶的光化学性质不变,还有就是光刻胶必须对水有一定的抗拒性,水扩散进入光刻胶不会导致胶体的膨胀和光敏感性的损失。 从市场占比上看,ArF/浸没ArF光刻胶是主流,约占整个半导体光刻胶市场的45%,其次是KrF,占到24%。
图表 2 2016年全球半导体光刻胶按产品分布结构

资料来源:上海新阳、亨通伟德投资
不同类型的半导体光刻胶其市场竞争结构不同,但主要以日系和美系厂商为主,例如在g/I line光刻胶和KrF光刻胶市场,东京应化工业株式会社占据着主要的市场份额,住友化学、信越化学、日本合成橡胶公司、富士胶片等厂商也是主要的竞争者。在ArF/浸没ArF光刻胶市场则形成日本合成橡胶公司、信越化学、东京应化工业株式会社三家主导,其余日系美系厂商跟随的局面。
图表 3 2016年不同类型半导体光刻胶市场竞争格局

资料来源:上海新阳、亨通伟德投资
接着我们看看下光刻胶的市场情况,根据SEMI的数据,2016年全球半导体用光刻胶及配套材料市场分别达到14.5亿美元和19.1亿美元,同比分别增长9.0%和8.0%。预计2017和2018年全球光刻胶市场将分别达到15.3亿美元和15.7亿美元。随着12寸先进技术节点生产线的兴建和多次曝光工艺的大量应用,193nm及其它先进光刻胶的需求量将快速增加。其中193nm(ArF)光刻胶在高阶半导体制造(≤10 nm logic)制程光刻胶的出货量仍将处于持续快速增长状态。
图表 4全球半导体光刻胶市场现状及预测(单位:亿美元)

资料来源:SEMI、亨通伟德投资
中国市场方面,根据智研咨询的数据,2017年中国光刻胶行业产量达到7.56万吨,同比增加0.29万吨; 2017年中国本土光刻胶行业价格为7.35万元/吨。目前我国从事半导体光刻胶研发和生产的企业主要有北京科华微电子材料有限公司和苏州晶瑞化学股份有限公司,目前这些企业的主要产品为248nm、G/I线等光刻胶材料。
图表 5 2011-2017年中国光刻胶行业产量及价格情况(单位:万吨、万元/吨)

资料来源:智研咨询、亨通伟德投资
另外根据SEMI的数据,2017年中国光刻胶及配套试剂市场规模分别为20.2和24.24亿元,同比分别增长6.8%和23.8%。
图表 6 中国光刻胶及配套试剂市场规模(单位:亿元)

资料来源:SEMI、亨通伟德投资
接下来我们介绍一下CMP抛光材料。CMP工艺的基本原理是将待抛光的硅片在一定的压力下及抛光液(由超细颗粒、化学氧化剂和液体介质组成的混合液)的存在下相对于一个抛光垫作旋转运动,借助磨粒的机械磨削及化学氧化剂的腐蚀作用来完成对工件表面材料的去除,并获得光洁表面。CMP技术所采用的设备及消耗品包括:抛光机、抛光液、抛光垫、后CMP清洗设备、抛光终点检测及工艺控制设备、废物处理和检测设备等。其中抛光液和抛光垫为消耗品,抛光机、抛光液和抛光垫是CMP工艺的3大关键要素,其性能和相互匹配决定CMP能达到的表面平整水平。
先看抛光液,CMP抛光液又叫CMP研磨液,或CMP磨料,是平坦化工艺中研磨材料和化学添加剂的混合物,CMP抛光液一般由超细固体粒子研磨剂、表面活性剂、稳定剂、氧化剂等组成。固体粒子提供研磨作用,化学氧化剂提供腐蚀溶解作用。抛光液是技术含量高,同时又很复杂的一种化学材料,作为目前唯一全局平坦化技术中所必须使用的耗材,它的浓度、磨粒的种类、大小、形状及浓度、粘度、pH值、流速、流动途径、稳定性等都对去除速度与效率产生大的影响。CMP的核心技术主要体现在两个方面,一是配方技术;二是研磨颗粒和化学添加剂类型。
CMP抛光液一般由去离子水、抛光浆料、PH值调节剂、氧化剂以及分散剂等添加剂组成。抛光浆料在抛光过程中主要通过微切削、微划擦、滚压等方式作用于工件被加工表面,去除表面材料。最理想的CMP过程是抛光浆料的机械去除表面材料厚度等于化学反应生成物层厚度,此时,磨粒只需较小的机械作用去除结合力较弱的化学反应层的生成物,可减少或避免抛光表面缺陷。抛光浆料的硬度、粒径、形状及其在抛光液中的质量浓度等综合因素决定了磨粒的去除行为和能力。
抛光浆料的成分主要由三部分组成:腐蚀介质、成膜剂和助剂、纳米磨料粒子。按pH值分类,抛光浆料主要分为两类::酸性抛光浆料和碱性抛光浆料。一般酸性抛光浆料都包含氧化剂、助氧化剂、抗蚀剂、均蚀剂、pH调制剂和磨料。氧化剂起在被抛光物件表面发生氧化腐蚀作用,然后通过机械作用去除表面凸起部分,使物件表面平整。另外,氧化剂还能氧化基体表面形成一层氧化膜从而提高选择性。助氧化剂起到提高氧化速率的作用。均蚀剂可使腐蚀均匀,从而使表面光滑细腻;抗蚀剂的作用是在被抛光物件表面与被腐蚀基体形成一层联结膜,从而阻止腐蚀的进行以提高选择性。而碱性抛光浆料中一般包含络合剂、氧化剂、分散剂、pH调制剂和磨料。因为碱性抛光浆料仅在强碱中才有很宽的腐蚀领域,而且磨料易造成划伤,所以应用远不如酸性抛光浆料广泛。对于不同的腐蚀基体要选择不同的络合剂,分散剂一般为大分子量非离子有机分散剂,其作用是保证浆料中的磨料不发生絮凝和沉降现象,并使磨料的勤度保持尽可能低,具有良好的流动性。
目前使用最为广泛的几种抛光浆料有CeO2抛光浆料、Si02抛光浆料、A1203抛光浆料等。*土稀**氧化物CeO2具有很好的抛光性能,其特点是抛光速率高,对材料的去除率高,被抛光表面粗糙度和表面微观波纹度较小,颗粒硬度低,对被抛光表面损伤较弱。其缺点是易划伤且高低选择性不好。Si02抛光浆料的优点是选择性和分散性好,机械磨损性能较好,化学性质较活泼,后清洗过程废液处理较容易,其缺点是硬度较高,易在被抛光物体表面造成不平整,且在抛光浆料中易产生凝胶现象,对抛光速度的再现性有不良影响,同时会使被抛光物体表面产生刮伤。
抛光液中常常添加一些化学试剂用于调节抛光液的PH值,以保证抛光过程化学反应的进行,CMP抛光液一般分为酸性和碱性两大类。酸性抛光液最早是由化学腐蚀液改进而来的,具有溶解性强、氧化剂选择范围大、抛光效率高等优点,常用于金属材料的抛光,其缺点是腐蚀性强,对抛光设备要求高,选择性较低。碱性抛光液具有选择性高、腐蚀性弱等优点,一般用于非金属材料的抛光。
在抛光之前要对抛光液进行过滤,滤掉磨料聚集产生的微量大尺寸磨料颗粒,往需要在抛光液中添加分散剂来提高抛光液的分散稳定性,以减少溶液中磨料粒子团聚。在抛光过程中,为了能够较快地在抛光表面形成一层结合力弱的氧化膜,有利于后续的机械去除,常常会在抛光液中添加氧化剂。在氧化剂的氧化腐蚀和磨料的研磨共同作用下,被加工表面可达到高质量的全局平坦化效果。在抛光液中加还要入合适的表面活性剂,能够改善抛光液的分散稳定性,使分散剂吸附在磨粒的表面,从而改变磨粒的表面性质,增强了颗粒间的排斥作用能 。
再看抛光垫,抛光垫通常使用聚亚胺脂材料制造,利用这种多孔性材料类似海绵的机械特性和多孔特性,表面有特殊之沟槽,提高抛光的均匀性,垫上有时开有可视窗,便于线上检测。抛光垫有软垫,硬垫之分。硬垫较硬,抛光液固体颗粒大,抛光速度较快,平行度、平整度也较好, 但表面较粗糙,损伤层较严重。软垫具有更好的硅片内平均性,抛光液中固体颗粒较小,因此可以增加光洁度,同时去除粗抛时留下的损伤层。故采用粗精抛相结合的办法,既可保持晶片的平行度、平整度,又可达到去除损伤层及保持硅片表面高光洁度的目的。
抛光垫上有很多小孔,这些小孔有利于输送浆料和抛光,还可用于将浆料中的磨蚀粒子送入硅片表面并去除副产品。在使用中,抛光垫在对若干片晶片进行抛光后被研磨得十分平整,同时孔内填满了磨料粒子和片子表面的磨屑聚集物,一旦产生釉化现象,就会使抛光垫失去部分保持研浆的能力,抛光速率也随之下降,同时还会使硅片表面产生划伤,对电路元件造成损伤。
根据SEMI的数据,2017年全球CMP抛光材料的市场规模约17.2亿美元,同比增长4.88%,其中中国CMP抛光材料的市场规模约25.71亿元,同比增长10.72%。
图表 7 全球CMP材料市场规模(单位:亿美元)

资料来源:SEMI、亨通伟德投资
图表 8 中国CMP材料市场规模(单位:亿元)

资料来源:SEMI、亨通伟德投资
目前全球抛光垫市场主要被陶氏化学公司所垄断,市场份额约80%,其他供应商还包括日本东丽、3M、台湾三方化学、卡博特等公司。抛光液方面,目前主要的供应商包括日本Fujimi、日本Hinomoto Kenmazai,美国卡博特、杜邦、Rodel、Eka,韩国ACE等公司,占据全球90%以上的市场份额。
图表 9 全球CMP市场供应商市占率

资料来源:中国产业信息网、亨通伟德投资
中国本土厂商方面,安集微电子团队研发出了具有中国自主知识产权的研磨液, 打破国际垄断,目前公司正在瞄准国内目前最先进的14nm工艺研发产品,推出其配套的研磨液。