新一代手持式电子产品的微小型化、多功能和智能化要求,使得高密度组装板(High-Density Assembly PCB)及高密度互连(HDI)多层电路板应用日益广泛。传统的层压印制电路板制造工艺,已经不能适应微细间距元件的应用需要,从而开发了高密度互连电路板制造技术。HDI 板是指线宽/线距小于等于0.10 mm、微导通孔径小于等于 0.15 mm的 PCB。
这些产品要求基板材质具有高耐热性、良好的机械性能、低介电常数、低热膨胀系数等要求,它们的层数结构及制作工艺也变得更为复杂。
高密度组装PCB的基本材质特性和要求
高性能有机硬性 PCB 基材,通常是由介电层(环氧树脂、玻璃纤维)和高纯度的导体(铜箔 )两者所构成的。我们评估印制线路板基材质量的相关参数 ,主 要 有 玻 璃 化 转 温 度 Tg 、热膨胀系数 CTE、基材的耐热分解时间和分解温度 Td、电气性能、PCB 的吸水率、电迁移性CAF等。
印制基板材质 基本特性
在一些低端产品上,会用到棉质或纸质芯复合材料基板,不过这种材质的 PCB 板耐热性差、疏松易断、易受潮,在无铅焊接制程中会有起泡、发黄或分层等问题。对于复杂的精密电子组装板,通常须采用环氧树脂玻璃布复合基板,或者特性较好的复合材料等,它们的热性能和机械强度较好,用于精密产品上无问题;而金属基板和陶瓷基板仅用于特殊产品上。印制电路板的基板材料多种多样,常见的原料结构和基板特性可参考图表:

PCB 基材是以玻璃纤维、不织物料、以及树脂组成的绝缘部分,再以环氧树脂和铜箔压制成“黏合片”,板子本身的基板是由绝缘隔热、并不易弯曲的材质所制作成的。在新一代精密电子高密度互连多层电路板上应用广泛,它们对于基板的热性能、机械性能、环保要求都变得更为严格,层数结构及制作工艺也变得复杂。而 PCB 的尺寸稳定性、抗剥离强度,以及刚揉性、韧性等受制于基板材质特性,技术人员在设计或制程时需依据产品特点,材质的性价比、拼板组装效率、可靠性等做综合考量。
印制板按材质可分为有机材质和无机材质两种。有机材质中的覆铜箔层压板,因其性价比高应用非常之普遍,比如说 FR4,环氧树脂有阻燃 FR和非阻燃两种。另外,酚醛树脂玻璃纤维复合材料 CEM、BT/Epoxy 混合树脂和聚酰亚胺PI,在硬性基板和柔性基本上都应用广泛。而无机材质金属基板 MCPCB和陶瓷基板,它们在 LED 和影像产品 CIS组装板上得到了一定的应用,比如大功率LED 照明,便主要采用铝基板;而陶瓷基板可用于 CIS 产品上,其材质以氮化铝和碳化硅为主。
环氧树脂和BT树脂覆铜箔板 特点和应用
印制电路板最典型的基板材料有两种,即覆铜箔层压板 CCL和涂树脂铜箔 RCC,CCL 目前应用最广;而 RCC 是一种新型的多层板制作材料,它是生产积层板的重要基材。而树脂品质的优劣,很大程度上决定着印制层压板的可靠性,PCB 焊盘和焊点的坑裂有时就是树脂品质造成的。
高密度组装板对树脂特性的要求较高,PCB 硬性层压板通常较多地采用环氧树脂、多元酯、聚酯,以及 BT 树脂与环氧树脂的混合成材料。BT 树脂通常与环氧树脂混合制成基板,这种基本的 Tg 点可高达 180 ℃,耐热性能非常好,BT 制成的覆铜箔板材,铜箔的抗撕强度、挠性强度也很理想,介质常数小可用于高频和高速传输的电路板。
BT 树脂覆铜箔板的基本作用,有以下几个方面:
其一,它可作为 COB 设计的电路板,在 COB 芯片内电极与基板焊盘的互连是用 20~40μm 的金丝或硅铝丝,通过金丝球或超声波压焊工艺完成的,由于 Wire Bonding 过程的高温,会使基板表面变软而造成打线失败,而 BT/Epoxy 高性能基板可克服此缺点。
其二,作为 BGA\PGA\MCM\POP\PIP 等半导体集成或系统器件封装载板,半导体封装测试中,有两个常见的重要问题,即漏电现象 CAF和爆板现象(基板受潮及高温冲击),而 BT/Epoxy 基板对此缺点也可较好地克服。
其三,作为 IPD(集成无源元件)的基板,IPD 是在基板内埋置无源元件的新技术。随着电子设备功能的日益强大而体积的小型化要求,这种基板在一些特殊产品上已开始应用,它通过基板与组装工艺之间的结合,在多层板中预埋电阻、电容和电感等无源元件,这样既减少了外贴元件的数量,又实现了高密度组装及高可靠性。
高密度多层及小型化 HDI产品基板
小型化 HDI产品是指产品尺寸和重量的缩减,比如蓝牙耳机、智能手机和手持式智能产品等,这些产品通过提高布线密度设计,使用 CSP\FC 等小型元器件、6 层或 8 层板内部互连,并通过采用埋孔工艺结构来实现的。这种基板的厚度多半小于 1mm,为具有较高 Tg(160 ℃)的 FR4 材质。
高密度基板的 HDI 板通常在 4 层以上,层间以盲孔或埋孔实现互连,其中至少 2 层有微孔,它适用于 FC 或邦定键合基板,微孔工艺为高密度倒装芯片提供了足够的间距。微孔是为解决 PCB 高密度布线的,当前的微孔通过已由 CNC改为激光钻,有的 CSP 金属化孔尺寸甚至小于 100 μm,微孔工艺能够形成高 I/O 器件的间距。
高层数 HDI 板,通常是指第 1 层到第 2 层或第 3 层有激光钻孔的传统多层板,采用的是顺序叠层工艺,在玻璃增强材料上进行微孔加工。该技术的目的是预留足够的元件空间,以确保要求的阻抗水平,并适用于高 I/O 数或细间距元件的高层数 HDI 板。
在传统的多层板工艺中,所有层一次性堆叠成一块 PCB,采用贯通导通孔进行层间边接,而在 HDI 板工艺中,导体层与绝缘层是逐层积层,导体间是通过微埋或肓孔进行连接的。随着 PCB 基板互连密度的提高,全积层结构或称任意层互连也开始使用。因而,一般把 HDI 板工艺称为积层工艺 BUP或 BUM。根据微埋或肓孔导通的方法来分,还可以进一步细分为电镀孔积层和应用导电积层工艺。
在 HDI 板的工艺中,电镀孔工艺是主流的一种,几乎占 HDI 板市场 95%以上。它本身也在不断发展中,从早期的传统孔电镀到填孔电镀,HDI 板的设计自由度得到很大提高。电镀孔积层板的设计,主要考虑积层的层数以及埋孔、微肓孔的结构和微肓孔的尺寸。另外,还有任意层填隙式导通互连技术 ALIVH工艺,它是通过导电胶填孔实现积层的任意层间互连,全由埋肓导通孔来实现。其主要特点,一是使用无纺芳酰胺纤维环氧树脂半固化片为基材,二是采用二氧化碳激光形成导通孔并用导电膏填充导通孔,或是用导电膏凸点制成。
FPC 及 Rigid-FPC 材质及结构的主要特点
FPC是以聚酰亚胺或聚酯薄膜等为基材介质制成的挠性层压电路板。RFPC 即钢挠性接合板(Rigid-Flex PC),它是 PCB和 FPC 的混合制程产品。
FPC 导电线路有印制(蚀刻)和丝印两种,印刷工艺应用最为广泛,丝印又称为聚合物厚膜 PTF, PTF 是直接在介质上丝印导电油墨作为导体,如一些薄膜开关就是采用这种工艺。
FPC 的铜箔厚度常见的有 0.5oz\1oz \2oz,它们对应于公制 17.5μm\35μm\70μm。FPC按种类可分为:压延铜和电解铜。压延铜 RA,采用厚的铜箔多次重复压延而成,具有较高的延展性及耐弯曲性。压延铜一般用在耐弯曲的较高的 FPC 板上。电解铜 ED用电镀的方法形成,其铜微粒结晶状态呈垂直状,利于精细线路的制作。电解铜常用在弯曲性要求较低的 FPC 板上。多层 FPC 的基本结构及剖视解析,如图。
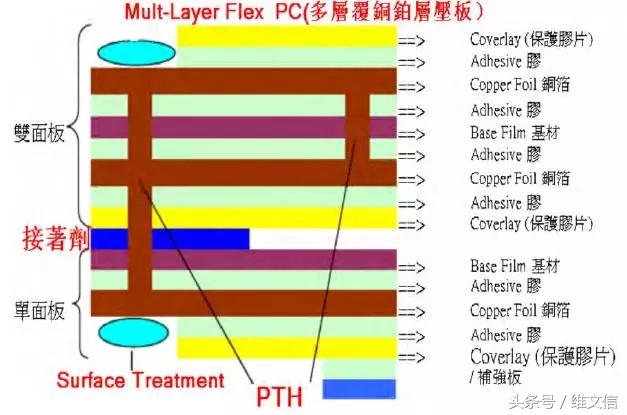
FPC 基材常用到的基材有两种:聚酯即通常说的 PET,这种材质价格低廉,电气和物理性能与聚先亚氨相似且能较好地耐潮湿,其厚度通为 1~5 mil。PET 适用于-40 ℃~55 ℃的工作环境,但耐高温较差,决定了它只能适用于简单的FPC,不能用于有零组件的 FPC 板上。聚先亚氨即通常所说的 PI,它具有优异的耐高温性能,耐浸焊性可达 260 ℃/20 s,几乎应用于所有的军事硬件和要求严格的商用设备中。PI 材质易吸潮,价格贵,其厚度通常为 0.5~5 MIL。
总之,FPC 或 Rigid-FPC 基材有压延铜(RA)和电解铜(ED),压延铜一般用于弯曲频度高的动态产品,电解铜则仅用于弯曲次数少的静态产品。绝缘介质常用的有聚先亚氨(PI)和聚酯(PET),PI 价格贵耐高温性能佳,耐浸焊性可达 260 ℃、20 s,不过这种材质易吸潮在 SMT 生产前需烘烤祛湿;而 PET 虽便宜却耐温性差不宜用于 SMT 回流焊接。

精密电子组装板的热性能要求与选择
在 PCB 选材与设计时,材质的机械性能和热性能要适合产品的特点,须考量回焊或波焊制程对板弯翘及应力问题。PCB 的尺寸稳定性、抗剥离强度、以及刚性和可靠性受基板材质影响较大,如果材质选择不合适,PCB 可能在组装前就已经变形,这将导致精密细间距器件的印刷不良。PCB 基板的布局及敷铜,要力求匀称使热应力均衡,譬如 PCB 覆铜板点铜比网铜郊果要更好。
基板材质 Tg、CTE、Td 认知
玻璃态转化温度(Tg):是玻璃态转换温度,温度一旦高于 Tg,物理特性变化非常明显,如同玻璃加热软化,特别是 CTE 增长很快;基板材质 Tg 是决定材料性能的临界温度,是选择基板材料的一个关键参数。
Td 是 PCB 基材分解温度,一般按照重量减少 5%的温度作为分解温度,但也有研究表明对于无铅组装 PCB 基板采用 5%还不合适,比如某一 PCB 材料 5%的温度达到 340 ℃左右,但无法承受无铅 250 ℃的温度,目前更倾向于 2%来衡量。而对于无铅而言,仅仅对PCB 基板要求 Tg 是不够的,至少还有同等重要的参数包括 Td、CET(特别是 Z 轴、与 Tg之后地 CTE)。基板或组装板在组装回焊或波焊时翘曲、分层,产生的机械应力和热应力,对微形焊点易产生虚焊、连锡、焊点锡裂等缺陷或焊盘坑裂等可靠性问题。
Tg 过低回焊时 PCB 易翘曲变形,PCB 的 I/O 焊端易产生共面性问题,以及机械应力和热应力对焊点和元器件的损坏。FR2\FR3\CEM1\CEM2 覆铜箔层压板 CCL,纸质芯基板疏松脆弱易断且易变形,热性能差,不宜用于倒装焊器件组装板;而硬质材料 FR-4/FR-5 用的较多;SMT 焊接用揉性 FPC 主要采用聚酰亚胺 PI材料。
基板材质 耐热性和电气性能
PCB 的尺寸稳定性、抗剥离强度、以及刚性和可靠性受基板材质影响较大,如果材质选择不合适,PCB 可能在组装前就已经变形,这将导致精密细间距器件的印刷不良。Sn-Pb合金焊接温度(220~230 ℃),印制板基材的耐热分解时间,在 260 ℃时,T260≥30 s 就可以满足 SMT 印制板的要求。SAC305 无铅焊接温度一般为(250~260 ℃),印制板基材的耐热分解温度应满足在 288 ℃条件下 T288≥300 s,才能保证焊接时基材不分解、性能不被破坏。
耐热性:
SMT 要求二次回流 PCB 不变形,传统有铅工艺要求:T260 ℃/耐50 s;无铅要求更高的耐热性:T260 ℃≥30 min;T288 ℃≥15 min;T300 ℃≥2 min。
电气性能有介电常数、介质损耗、抗电强度、绝缘电阻、抗电弧性能、PCB 吸水率等。介电常数:介电常数是高频电路所用基材的一项重要指标;当其大的时候,其信号传输速度会受到衰减,易发生信号失真及干扰.通常要求 SMB 基材的介电常数小于 2.5。
介质损耗:
当其偏大时,会引起基板发热,高频损耗增大;当电路工作频率大于 103 Hz时,通常要求 SMB 基材的介质损耗小于 0.02。
抗电强度:
需求板材厚度≥0.5 mm 时的击穿电压大于 40Kv。
绝缘电阻,潮湿后表面电阻大于10 000 MΩ;抗电弧性能大于60 s,PCB 吸水率小于 0.8%。
CAF 即(Conductive Anodic Filament)的缩写,它是电化学腐蚀过程的副产物,通常表现为从从电路中的阳极发散出来,沿着玻璃纤维与环氧树脂之间的界面表面朝着阴极方向迁移,形成导电性细丝物,从而导致绝缘电阻发生突然下降。
影响 CAF 形成的因素,主要受基板材质(形成的敏感性程度等级:MC-2≥Epoxy/Kevlar≥FR-4≈PI>G-10>CEM-3>CE>BT)、导体结构、电压梯度、助焊剂、湿度及潮气情况。印制板基材的耐离子迁移性:耐热性好、低吸湿率的基材和产品低湿度的工作环境有利于防止 CAF 现象,改进措施:加大孔间距和导通孔做塞孔处理设计等。
PCB 基本要求和选择因素
通常,我们根据产品的功能、性能指标及产品的档次选择 PCB,并选择高 Tg(150~170 ℃)环氧玻璃纤维基板的 FR4、CEM-3、FR5 等。SMT 对印制电路板的要求:SMT 无铅再流焊工艺,要求经受 235~260 ℃的高温环境,因此要求 PCB 基材耐高温、不变形、热膨胀系数低等要求。对于无铅焊接用FR4,基板的分解温度须高于 358 ℃,热态尺寸稳定性优异,尤其 Z 轴膨胀系数要小,耐离子迁移性好。对于散热要求高的高可靠电路板,采用金属基板;对于高频电路,则需采用聚四氟乙烯玻璃纤维基板。PTFE 基板,对称结构且具有优势的物理、化学和电器性能、在所有树脂中,PTFE 的介电常数和介质损耗最小。
SMT 对印制电路板的要求:外形尺寸稳定,翘曲度小于 0.007 5 mm/mm(超高密度翘曲度要求控制在 0.5%以内);焊盘镀层平坦,满足SMD 共面性要求;热膨胀系数小、导热系数高;耐热性要求严格;铜箔的附着强度高,可焊性好;良好的抗弯曲强度;电性能要求介电常数、耐压、绝缘性能要符合产品要求等。
选择 PCB 材料时应考虑的因素:适当选择玻璃化转温度较高的基材,Tg 应高于电路工作温度;CTE 要低,以免 PCB 变形严重时,造成金属化孔断裂和损坏元件;PCB耐热性须不低于 250 ℃/50 s;平整度和电气性能方面,如同 SMT 对印制板的一般要求。
基材 Tg 点决定材料性能的临界温度,是选择基材的一个关键参数,Tg 过低回焊时 PCB易翘曲变形。BT/Epoxy 树脂基板 Tg 点大于 180 ℃,其性能好可用作封装基材;高 Tg FR-4基材性价比好,Tg 范围为 170 ℃~190 ℃,可用于高性能产品上。
当多层基板的层压材料、玻璃纤维与铜箔之间的 CET 严重不匹配,应力可能造成金属化孔或半孔镀层断裂失效。PCB 基板为避免回焊时热应力损伤,Td 层分离裂解温度需不低于 340 ℃。研究表明,板材的高 Td 值比高 Tg 值更重要,如 Tg175/Td310 ℃比Tg140/Td350 ℃热性能稍次之,Td 与 Tg 都能达到规格则更好。
基材的耐热分解时间(T288)是反映印制板耐焊条件的一项技术指标,是指基板在288 ℃条件下经受焊接高温而不产生起泡、分层等分解现象的最长时间,该时间越长对焊接越有利。SAC305 焊接基板应满足 T288≥300 s,才能保证焊接时基材不被分解破坏。
基材的复杂多样,要求技术人员在设计和制程处理时须依据其特性有的放矢;如果选择处理不当,在制程工艺中易产生翘曲、分层,并造成产品的可靠性问题。基板或组装板在组装回焊或波焊时翘曲、分层,产生的机械应力和热应力,对微形焊点易产生虚焊、连锡、焊点锡裂等缺陷或焊盘坑裂等可靠性问题。
总结
常用印制电路板的基板材料可分为有机类和无机类基材两大类。有机类常见的有纸基、环氧玻璃布基、复合材料基、揉性基覆铜箔层压板,无机类基材有陶瓷基板、金属基板,以及高频电路用覆铜箔聚酰亚胺玻纤板、BT 树脂。而精密电子电路印制板,它们对于基板的材质、结构和热性能都有严格的要求。
微电子封装技术 MPT的日臻成熟,尤其在手持便携式产品上的推广应用;极小的 0201 和 01005 被动元件、微间距技术 MPT的超窄间距器件变得很普遍。电路板组装密度和集成度的骤然增高,以及电子产品严格的环保要求,不仅对于基板材质要求变得更为苛刻。在精密 PCB 设计选材时,我们需考察基材的热性能:玻璃化转温度 Tg、热胀系数 CTE、耐热分解时间和分解温度 Td。基板材质 Tg 是决定材料性能的临界温度,是选择基板材料的一个关键参数。Tg 过低回焊时 PCB 易翘曲变形,PCB 的 I/O 焊端易产生共面性问题,以及机械应力和热应力对焊点和元器件的损坏。
我们通过对精密电子电路印制板的结构、热性能及电气性能的认识,比如说高密度组装板的材质和结构特点、玻璃化转温度 Tg、热膨胀系数 CTE、PCB 分解温度 Td、耐热分解时间、介电常数、介质损耗、抗电强度、绝缘电阻、抗电弧性能、PCB 吸水率、电迁移性 CAF 等,使我们在做设计与基板选择时,更能做到心中有数、恰到好处。